摩爾精英:靈活高效的倒裝芯片封裝技術方案_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。02-17 16:45
芯片封裝目前逐漸向小型化、多引腳、高集成的方向持續發展,異構集成、2.5D、3D、SIP技術讓芯片封裝結構更加集成且複雜化。作為後摩爾時代芯片性能提升最佳途徑,以Flip-chip等為代表的先進封裝技術平台已成為中高性能產品封裝優選方案。Flip-chip封裝技術也憑藉成熟、完善的技術工藝平台,良好的電性能、熱性能,有競爭力的成本優勢,廣泛應用於各類中高端半導體器件封裝。
摩爾精英Flip-chip封裝解決方案
摩爾精英無錫SiP先進封測中心提供面向DPU、HPC、CPU、GPU、高端服務器、高性能ASSP、FPGA等產品的Flip-Chip封裝完整解決方案,包括封裝設計、仿真、工程批和量產。FCBGA整體產能可達1KK每月。此外,我們還提供系統級封裝 (System-in-Package)服務,和基於自主芯片自動化測試設備(ATE)的測試工程和量產。
支持定製化封裝解決方案:
• 少至1顆的封裝工程打樣
• 優化產品工藝的DOE設計
• 適配產品的多材料驗證
• 裸片&被動組件資源支持
• 客供材料的驗收&代保存
• 單製程封裝支持


• 可支持Wafer Node 7nm先進工藝晶圓芯片生產及5nm Wafer Node工藝開發
• 支持FCCSP封裝類型下最薄100um芯片厚度
• 支持FCBGA封裝類型下最薄400um芯片厚度
• 支持各項FCBGA封裝形式,Lid, Lid-less, Stiffener Ring, High Thermal Dispassion Material
• 支持最大65*65mm尺寸封裝及77.5x77.5封裝尺寸開發
• 支持最大65*65mm尺寸封裝及77.5x77.5封裝尺寸開發
支持最小7nm製程芯片晶圓,最薄100um for FCCSP及400um for FCBGA裸芯片,最小80um Bump Pitch,最大65*65封裝尺寸的各種單顆FCBGA產品的封裝。
摩爾精英封測中心技術管理團隊來自業內知名封裝廠商,平均年資超過15年,工程師團隊擁有支持領先芯片原廠的主流FCBGA類型產品的設計和封裝量產工作經驗。
基板資源
摩爾精英與一線封裝基板大廠深度合作,支持最高6~16層基板的生產,為客户提供打樣到量產產能保障。

摩爾精英無錫SiP先進封測中心建築總面積近1.5萬平方米,千級標準和萬級標準潔淨室超過5000平方米,設計年產能超過1億顆。封裝服務包括:FCCSP/FCBGA工程批和量產、SiP設計、SiP工程批和量產。
無錫SiP先進封測中心主要負責FCBGA工程批/量產,SiP設計/工程/量產及測試,目前月產能500-800萬顆;
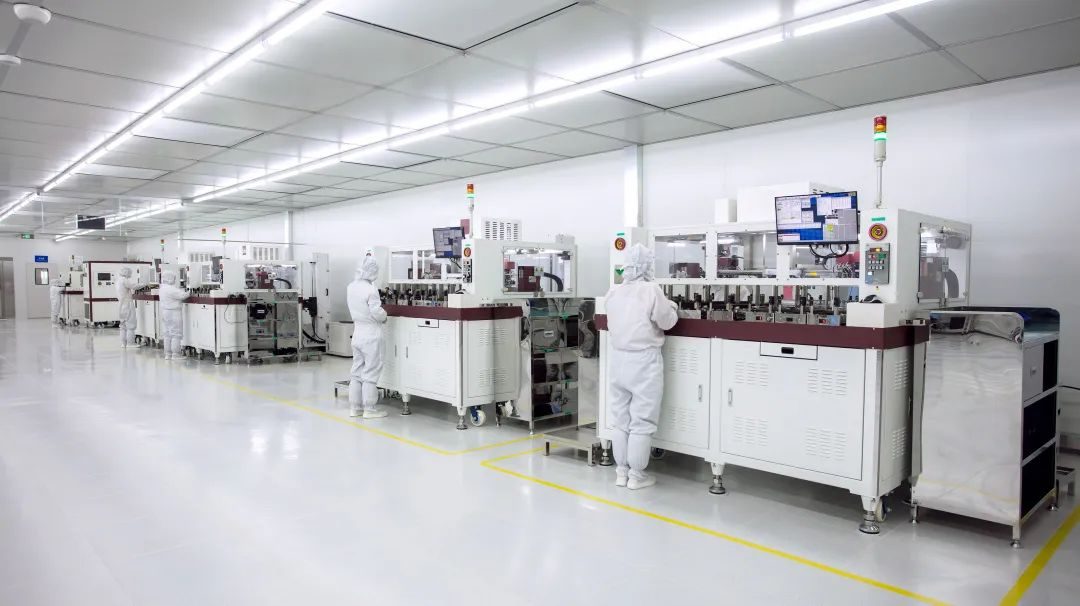
合肥快速封裝工程中心主要負責QFN/BGA/LGA工程批生產,目前月產能300批;

”
自年初試運營以來,摩爾精英無錫SiP先進封測中心已通過ISO9001:2015國際質量管理體系標準認證和QC080000認證;同時正積極籌備IATF16949認證,持續加大汽車芯片解決方案研發投入和產能佈局。
繼摩爾精英無錫SiP先進封測中心迎來了今年投產後的首個客户開放日之後。首屆“摩爾精英倒裝芯片封裝技術線上研討會”順利召開。會上分享的前沿基板市場資訊分享、雲看摩爾精英無錫SiP先進封測中心產線、摩爾精英靈活多樣化的Flip-chip封裝解決方案等技術乾貨獲得與會嘉賓廣泛好評。
關於摩爾精英

摩爾精英為客户提供平台化、定製化、產品化的芯片設計服務、IT/CAD設計平台服務、流片服務、封裝服務、測試服務、產品工程及量產管理服務和半導體教育培訓服務,幫助客户加速和差異化產品量產,提升研發和運營的效率,降低踩坑和失敗的風險。
摩爾精英在上海設立研發和運營總部,引進了國際領先IDM的芯片自動測試設備(ATE),在美國達拉斯和法國尼斯設有兩個海外研發中心,在無錫、重慶、合肥等地建設2萬平封裝測試工廠,核心設備投資超過3億元,供應鏈合作伙伴覆蓋全球主流晶圓廠和封裝測試廠。

