顛覆EUV光刻?不讓ASML獨美!_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。03-07 18:23
ASML 的 EUV 光刻工具很貴。每個 EUV 工具現在接近 1.7 億美元,但您還是將其中的許多工具用於領先的半導體工廠。未來,每個 High-NA EUV 工具的成本將超過 3.5 億美元。此外,這些晶圓廠還需要許多 DUV 光刻工具。每個人都想要一種更具成本效益的方式來圖案化芯片,因為僅光刻就消耗了 3nm 工藝節點成本的約 35%。
想象一下,如果有辦法打破這種趨勢。
上週,世界第二大半導體設備製造商應用材料公司宣佈他們有一個潛在的解決方案。該解決方案就是 Centura Sculpta 工具,這是一種可以執行新工藝步驟“pattern shaping”的新工具。
根據 Applied Materials 的説法,Sculpta 工具可用於將某些層的 EUV 光刻的使用減少一半之多。如果屬實,這將重塑行業的成本結構。不過筆者對 Applied Materials 的説法有很大的懷疑空間,所以讓我們來談談這個討論的細微差別。
在這篇文章中,我們將深入探討新的 Centura Sculpta及其相關影響。
首先,儘管有一個非常明確的用例,但半導體和金融行業的人們對這個工具有很多不屑一顧的地方。有人爭辯説,這並不是什麼新鮮事,它只是一種非常昂貴的電感耦合等離子體形式,用於進行反應離子蝕刻,這在大批量製造中已經存在了數十年。對此,人們也可能會爭辯説,光刻技術已經存在了 150 年,而 EUV 也不是什麼新鮮事物。shaping顯然是獨一無二的。
另一個主要的駁斥是它不成熟,而且還很遙遠。那也是錯誤的。雖然 Sculpta 上週才在 SPIE 的光刻和高級圖案會議上正式宣佈,但這個新工具已經推出很長時間了。至少從 2015 年開始,應用材料公司就一直在發佈關於這種工具類型的公開研究論文。
自 2017 年以來,該公司的第一個客户一直在與應用材料公司合作開發該工具。Applied Materials 甚至在去年的 SPIE Advanced Lithography & Patterning 會議上進行了技術演示,並提供了真實的客户測試數據。
關於該特定的演示文稿,還有個有趣故事。在應用材料的演示結束後,我們離開了演示室,並與一些與會者進行了交談。普遍的共識是它非常酷,但行不通。為什麼?參與 SPIE的公司演講分為 3 類。1,什麼即將投入生產,2,什麼是多年以後,在地上種下一根木樁,3,什麼根本不起作用但正在呈現,因為沒有其他與數據有關的東西。我們去年的假設是應用材料這個技術是介護#2 和/或#3之間。
現在看來,那是一個錯誤的假設。
Applied Material 的 Centura Sculpta 並不是完全不成熟且遠離生產的瘋狂技術。Sculpta 是真實的,它確實有效,它將在未來幾年內產生數億美元的收入。鑑於它被宣傳為在第一個用例中直接去除 EUV 雙重圖案化,首先讓我們快速回顧一下光刻多重圖案化過程。
光刻多重圖案化工藝
光刻是大批量半導體制造的核心工藝。一旦突破了光刻工具的限制,您仍然可以通過轉向各種多重圖案化方案來繼續縮放單個特徵尺寸。下面是“光刻-蝕刻-光刻-蝕刻 (LELE:litho-etch-litho-etch)”的簡化描述,這是最常見的多重圖案化方案之一。為了簡單起見,我們將把其他方案(如 SADP 和 LELB)放入與 LELE 相同的桶中。
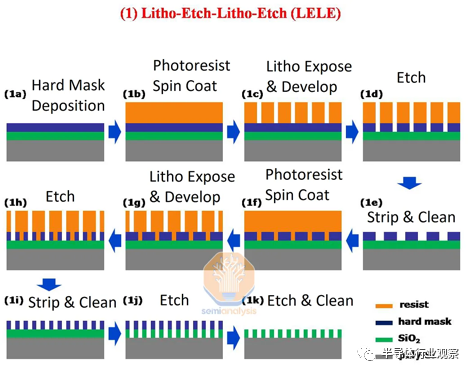
關鍵在於,從單一的光刻週期到 LELE 工藝涉及到雙倍的光刻成本以及該工藝中涉及的許多其他工具。
Applied Materials 專門將 EUV 多重圖案化減少作為Sculpta 的第一個用例。他們聲稱他們可以通過單個光刻週期和 Sculpta 實現與 LELE 相同的特徵保真度。
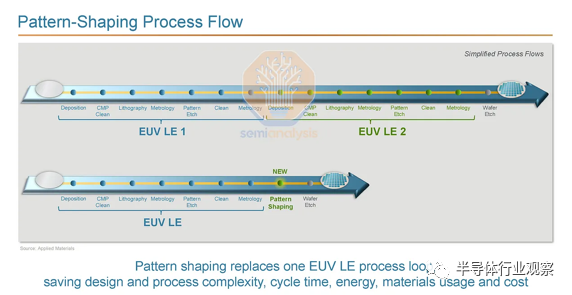
從上述可以看到,Applied Materials 宣稱的成本、電力、水和 CO2 節約量是巨大的。台積電已將其 7 納米和 5 納米節點的產能提高到(大約)每月 200,000 片晶圓。每層,這將為他們節省 5 億美元的資本支出和超過 1 億美元的年度運營費用。
台積電 5nm 具有 EUV 多重圖案化步驟。TSMC 3nm 包含多個 EUV 多重圖案化步驟。該技術的目標是插入“2nm”級節點,該節點可能包含 10 多個 EUV 多重圖案化步驟,而無需 Applied Materials Sculpta pattern shaping。如果您假設 Sculpta 可以在*任何地方*使用,那麼使用 Sculpta 每年可以節省*數十億美元*。
不過我們還需要重申一下,該分析過於簡單化,因為我們不能在所有地方使用pattern shaping 。我們將分享它的使用地點和方式,但首先讓我們來談談什麼是 Sculpta 和模式塑形。
什麼是 Centura Sculpta 和****Pattern Shaping?
Centura Sculpta 的核心是能夠執行一種稱為pattern shaping的新型步驟。pattern shaping是以一定角度向晶圓射出帶狀等離子束。與晶圓相比,角度可以控制在0到70度之間。零角與晶圓的角度成 90 度。
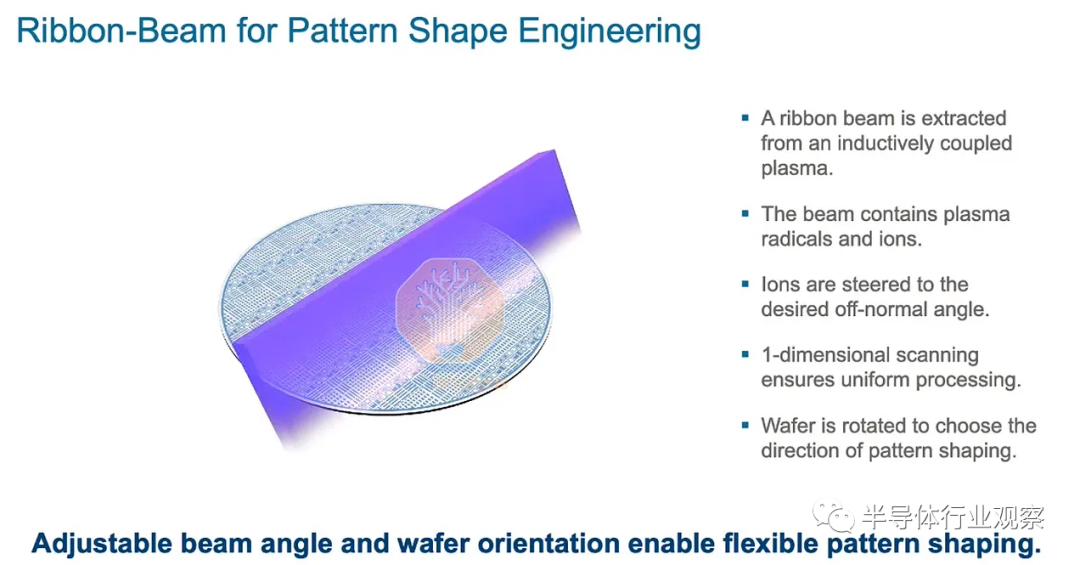


保持形狀統一的另一個考慮因素是確保針對晶圓上的各種不同結構優化光束角。
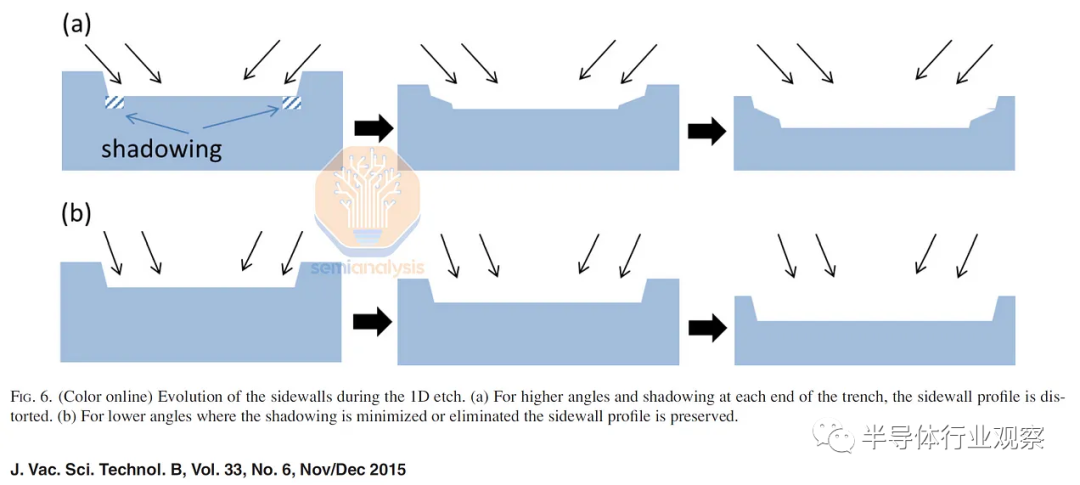
如果平坦化層和硬掩模具有不同的蝕刻選擇性,則等離子束將導致側壁不均勻平直。
必須優化特徵的側壁輪廓,否則會出現性能、功率或良率問題。
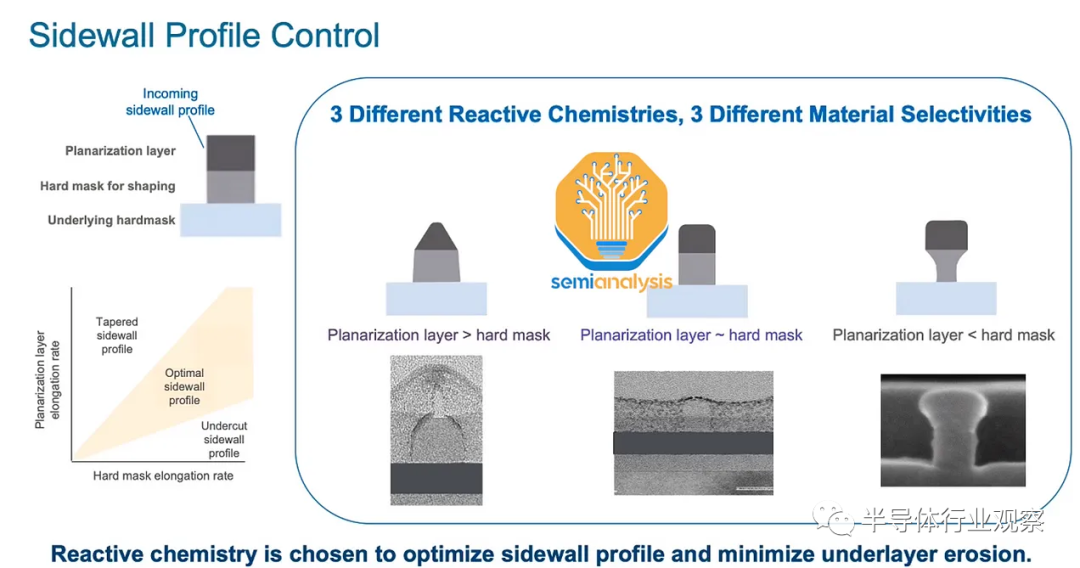

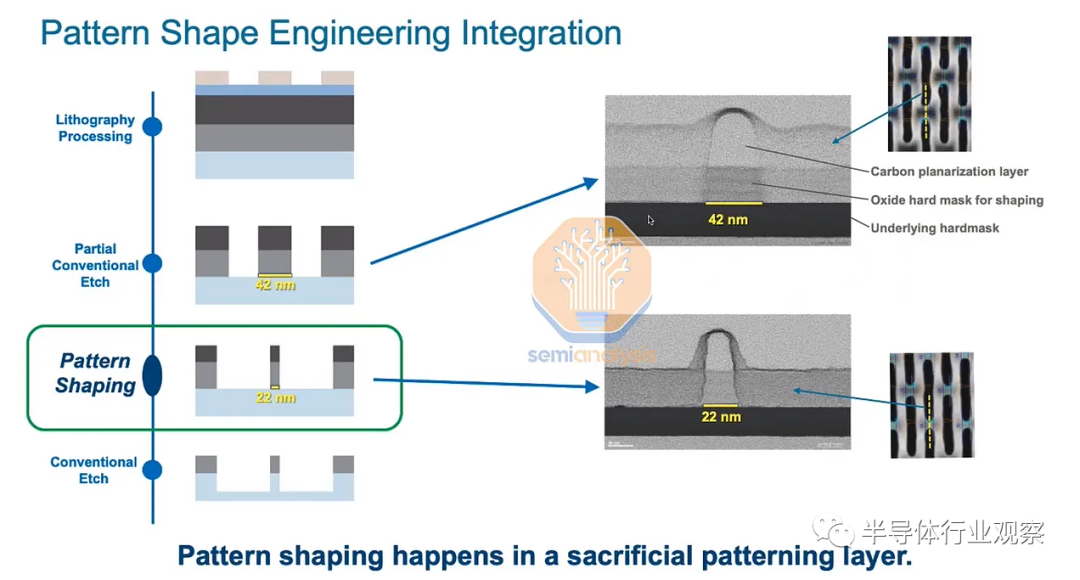
圖案成型不僅僅需要朝着現有特徵的方向發展。它也可以在任何任意角度進行。對我們來説,這似乎更多地展示了 Applied 與 Sculpta 的對齊和製程控制,而不是非對稱整形的實際用例。我們想不出非對稱整形的用例,但如果您認為有,請分享。
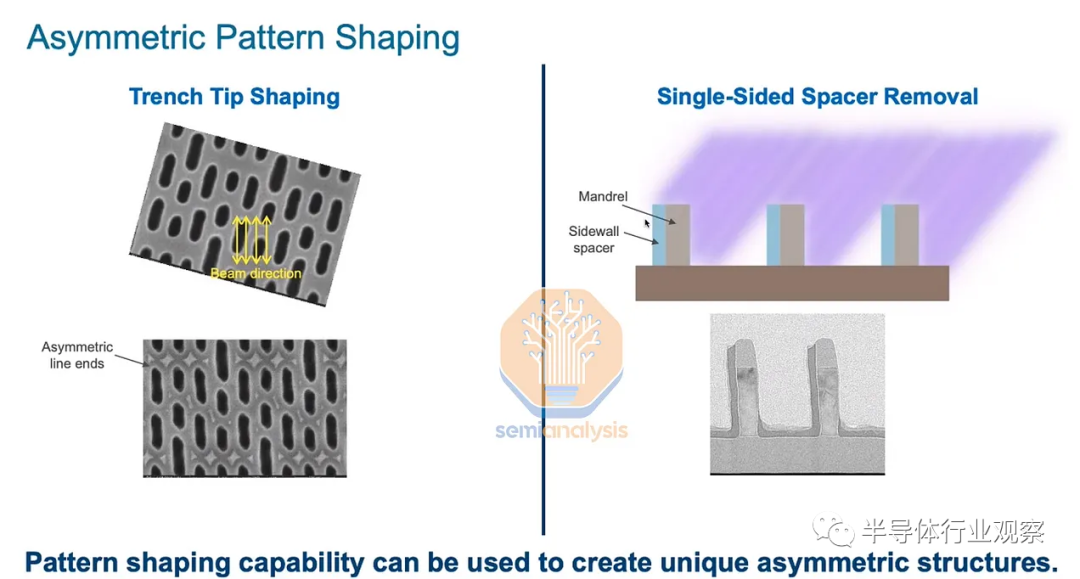
用 例
Scuplta 工具有 3 個主要用例:緊密的孔(Tight hole )和槽圖案(slot pattern)、更窄的尖端到尖端圖案(narrower tip-to-tip patterns)以及消除隨機橋接(removing stochastic bridging)。
第一個應用是使用傳統的光刻 (LE) 方法獲得具有緊密角對角尺寸的孔和槽圖案,這需要多重圖案化。藉助圖案整形,您的優勢在於只需使用一個 LE 步驟即可從一個角落到另一個角落。緊密的角對角很重要,因為它可以讓您將更多功能放入同一區域。在這種使用過孔的情況下,由於有更多的過孔區域,因此可以提高性能和功率特性。
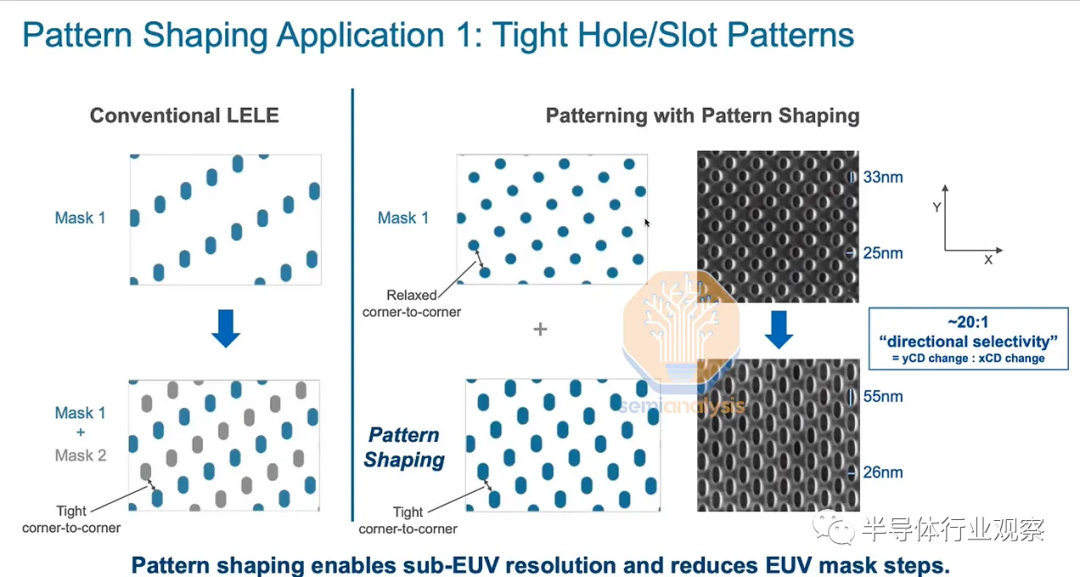
第二個應用是生產具有更緊密的尖端到尖端圖案的溝槽。這與第一個應用程序非常相似,但具有不同的功能類型。在此應用中,圖形整形用於在不使用第二個掩模的情況下使兩組線儘可能靠近。


這些缺陷會導致電子去不該去的地方而增加功率。如果橋最終將 2 個關鍵層連接在一起導致短路或通信錯誤,它也會導致產量降低。Applied Materials 表示,通過圖案整形,Sculpta 可以將這些缺陷減少 90% 以上。