芯片巨頭的“新”戰場_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。03-09 15:43
在今年的光纖通信會議(OFC) 會議上,光電共封(CPO)成為芯片廠商的一大熱議話題,博通、Marvell介紹了各家的採用光電共封裝技術的51.2Tbps的交換機芯片,思科也展示了其CPO技術的實現可行性原理,在光電共封技術的支持下,一個交換機的新時代正在來臨!這對於光電共封技術來説是一個很大的進步,也足以表明利用光來移動數據的前景確實是光明的。
這個賽道也成為了芯片巨頭的新戰場。
光電共封迎來大的推動力
這一波的光電共封器件很大的推動者是數據中心的公有云供應商,隨着AI/ML(人工智能/機器學習)、高分辨率視頻流和虛擬現實等更高帶寬應用的出現,網絡流量持續增長,數據中心網絡承受的壓力也在不斷增加,諸如谷歌、Meta、亞馬遜、微軟或阿里巴巴等,他們每家都部署了數萬台交換機,而且正在推動數據速率從100GbE向400GbE和800GbE更高速的數據鏈路的方向發展,這將消耗更多的電力來通過銅纜傳輸數據。
作為交換機的大腦——交換機芯片,在過去多年來主要有兩大長期發展趨勢:
一,大約每兩年一次,交換機芯片的帶寬會翻一番,這也很好的遵循了摩爾定律。二,為了支持總交換機芯片帶寬的增加,Serdes的速度、數量和功率也在隨之增加,SerDes的速度從10 Gbit/sec增加到112 Gbit/sec,芯片周圍的SerDes數量從64通道增加到51.2 Tbps一代的512通道。SerDes功率成為系統總功率的很大一部分。
當下交換機之間所採用的方案大都是可插拔的光學器件,雖然可以很容易地更換或換成更高容量的,但這也意味着在交換機芯片和光學器件接口之間有幾英寸的銅,而且由於所需的電氣和光學密度、熱問題和功耗,當前可插拔光學器件也面臨着容量難擴展的制約。於是,業界開始探索提高數據中心效率的新方法,光電共封(CPO)成為一個有利的選擇!
光電共封裝(Co-Packaged Optics,簡稱CPO)是一種新型的光電子集成技術,它將光學器件(如激光器、調製器、光接收器等)封裝在芯片級別上,直接與芯片內的電路相集成,藉助光互連以提高通信系統的性能和功率效率。共同封裝光學器件的一項關鍵創新是將光學器件移動到離 Switch ASIC 裸片足夠近的位置,以便移除這個額外的DSP(見下圖)。藉助CPO,網絡交換機系統中的光接口從交換機外殼前端的可插拔模塊轉變為與交換機芯片組裝在同一封裝中的光模塊。
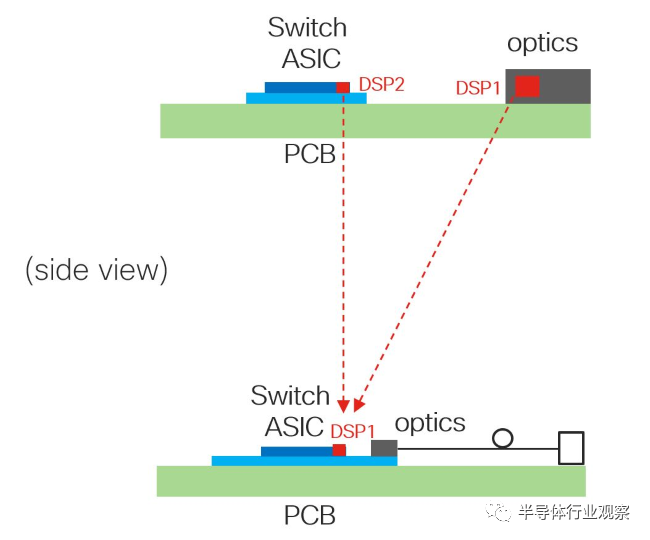
增強性能:CPO可以將光學元件直接嵌入芯片中,使得光學元件與芯片內部電路的距離更近,減小了電信號的延遲和失真,提高了通信系統的性能。節省空間:CPO可以大大減小光模塊的尺寸,尤其是在高密度數據中心環境下,可以將更多的端口裝在相同大小的機櫃中。降低功耗:CPO可以減少能量轉換的步驟,從而降低了功耗。與傳統的光模塊相比,CPO在相同數據傳輸速率下可以減少約50%的功耗。提高可靠性:CPO可以提高光學和電子之間的互聯可靠性,並減少外部干擾。同時,由於CPO是在芯片級別上封裝的,所以也能夠提高整個系統的可靠性。降低成本:CPO可以減少芯片與光模塊之間的連接器數量,從而降低了生產成本。此外,CPO的小尺寸和低功耗也能夠降低運營成本。
正因為此,使得越來越多的芯片廠商、光通信廠商和研究機構都在積極研究和使用光電共封技術。
CPO的商業化雛形,在交換機市場中顯現
博通
博通(Broadcom)涉足光電領域大約在1990年,1995年,Broadcom推出了其第一款光電收發器,這是該公司進入光電領域的開端。此後博通進行了一系列收購,1998年收購了光通信設備製造商Epigram;2000年,Broadcom收購了另一家光通信設備製造商Luminent;2016年,Broadcom收購了從事光電器件和模塊研發的BroadLight。
可以説,通過不斷收購,高通進一步加強了其在光電領域的研發能力,博通也開發出了電子、光學和創新封裝架構 (SCIP™) 。養兵千日,如今,博通正將其在光電領域的技術積累應用到交換機產品中。
博通在2023年光纖通信會議(OFC) 上談到了其最新的交換機產品——Broadcom Tomahawk StrataXGS 5,它在單個單片芯片中提供 51.2 Tbps 的以太網交換容量。如下圖所示,該交換機值得一提的地方是,Tomahawk 5採用了光電共封裝的技術,它將交換機芯片和100G PAM4接口共同封裝在一起,這種新芯片能夠減少將信號驅動到交換機前端的可插拔光學器件的需求,大大降低了功耗。相比於Tomahawk 4 Humboldt 25.6T 6.4W的功率,該交換機僅需要5.5W的功率為800Gbps的流量供電。博通稱,由於採用了光電共封(CPO)的光學技術,該芯片能將光學連接所需的功率降低50%以上。

除了交換機芯片之外,博通還有光電共封的收發器產品。它也採用了博通的硅光子芯片封裝 (SCIP™) 技術。

(圖源:博通)
Marvell
Marvell Teralynx 10交換機是另一款專為800GbE時代設計的51.2T交換機,該交換機由Marvell的Teralynx 10 51.2 Tbps交換芯片和 PAM4 1.6 Tbps 光電平台 Nova組成。Teralynx 品牌來自Marvell-Innovium的收購。
Marvell Teralynx 10芯片跟博通的一樣,也是一款可編程5nm單片交換機芯片,具有512個112G SerDes,能滿足32 x 1.6T、64 x 800G和128 x 400G廣泛的交換機配置。按照Marvell的説法,一個Teralynx 10取代了12個12.8 Tbps一代,而且在同等容量下能減少80%的功耗。

Teralynx 10使用了Teralynx 獨有的通用超低延遲開關和緩衝結構,還支持擁塞感知路由和實時流遙測,使網絡能夠自動調整和自我修復。藉助線速可編程性,可以添加新的協議和功能來滿足AI/ML不斷變化的需求。Teralynx 10 支持廣泛的實時網絡遙測,包括 P4 帶內網絡遙測 (INT)。這些功能支持預測分析、更快的問題解決和更高程度的自動化。
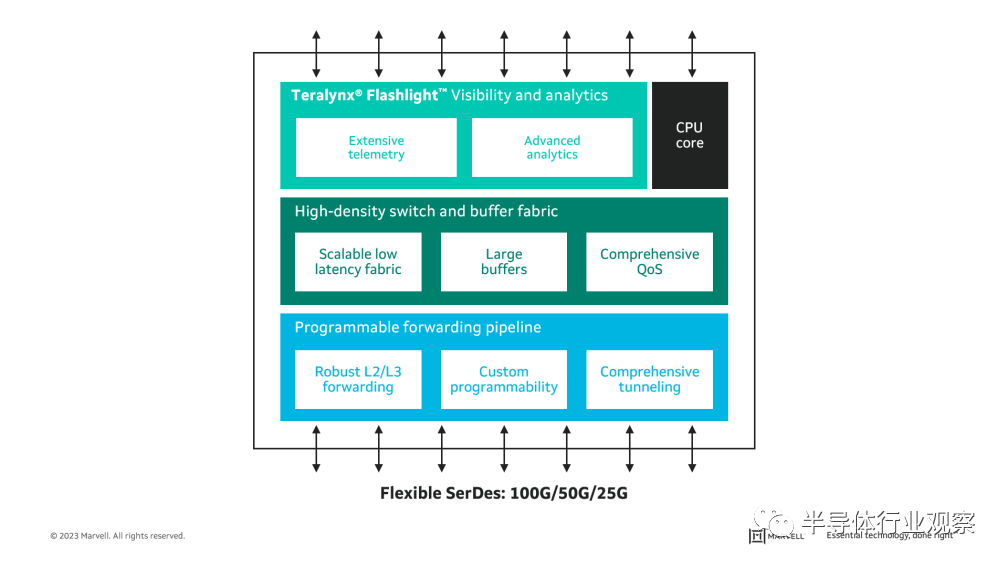
這款新的交換機芯片可以減少AI/ML等分佈式應用程序在網絡上花費的時間,最大限度地提高計算利用率,並滿足人工智能和機器學習不斷增長的帶寬需求。它適用於下一代數據中心網絡中的枝葉和主幹應用程序,以及 AI/ML 和高性能計算 (HPC) 結構。Teralynx 10將在第二季度提供樣品。
思科
思科也在進行光電共封技術的探索,其正在和芯片製造商Inphi之間基於CPO的交換機/光學解決方案的合作,為下一代 51.2 Tb/s交換機和800 Gb/s可插拔設備開發聯合封裝光學器件 (CPO)。
在本次OFC 2023上,思科也演示了CPO技術實現的可行性具體步驟。思科指出,其Cisco 8111-32EH是一種傳統的32端口2x400G 1RU路由器,基於Cisco Silicon One G100 ASIC的2x400G-FR4可插拔光學模塊(64x400G FR4)。思科CPO路由器配備了完整的協同封裝的基於硅光子學的光學tiles,驅動64x400G FR4,也基於帶CPO襯底的思科Silicon One G100 ASIC。思科還發明瞭一種在硅光子IC上執行此複用器/解複用器的創新方法。思科預計試驗部署與 51.2Tb 交換機週期同時進行,隨後在 101.2Tb 交換機週期內更大規模地採用。

英特爾
在光電共封這一技術上,英特爾是資深的玩家之一。2015年宣佈推出其co-package photonic技術。為了提供經濟高效的互連解決方案,英特爾一直在增加其硅光子學的帶寬,並在不斷探索使用一體封裝的光學器件。
2019年,Intel收購了以太網交換機芯片和數據中心軟件領域的新興領軍企業Barefoot Networks,2020年3月,英特爾展示了12.8 Tb/s Barefoot Tofino 2交換機與1.6 Tb/s集成光子引擎共同封裝的方案,硅光互連平台採用1.6 Tbps光子引擎,在Intel硅光平台上設計和製造,可提供4個400GBase-DR4 接口。英特爾表示,使用一體封裝的光學器件,可將光學端口置於在同一封裝內的交換機附近,從而可降低功耗,並繼續保持交換機帶寬的擴展能力。英特爾還表示,其51.2 Tb/s解決方案應該可以在2023年底進行商業部署,

CPU和GPU廠商的試煉
相信英特爾如此致力於硅光研究不是僅僅為了能與交換機新芯片共連,未來光學器件如果能否與CPU、GPU或XPU集成在一起也不得而知。
我們看到,英特爾花費了很大的心力,從多種路徑進行對光互聯技術的支持。2022年6月30日,英特爾研究院展示了完全集成在硅晶圓上的八波長分佈式反饋(DFB),激光器陣列,該陣列輸出功率均勻性達到+/- 0.25分貝(dB),波長間隔均勻性到達±6.5%,這項最新的光電共封裝解決方案使用了密集波分複用(DWDM)技術,展現了在增加帶寬的同時顯著縮小光子芯片尺寸的前景。而且更重要的是,它是在英特爾的商用300 mm混合硅光子平台設計和製造的,因此,它為下一代光電共封裝和光互連器件的量產提供了一條清晰的路徑。
在2022年英特爾On峯會上,英特爾又展示了其正在開發的一項創新:在可插拔式光電共封裝(pluggable co-package photonics)解決方案上的突破。英特爾的研究人員設計了一種堅固的、高良率的、玻璃材質的解決方案,它通過一個可插拔的連接器簡化了製造過程,降低了成本,為未來新的系統和芯片封裝架構開啓了全新可能。
英特爾可插拔連接器
(圖源:英特爾)
英偉達也看中了光互連的潛力,互連的 GPU 將受益於低延遲數據傳輸和顯着減少的信號損失。Nvidia或將在下一代 NVSwitch上實施聯合封裝光學器件以實現節點間通信,這些系統應該在互連的NVLink 網絡中支持約4,000個GPU。
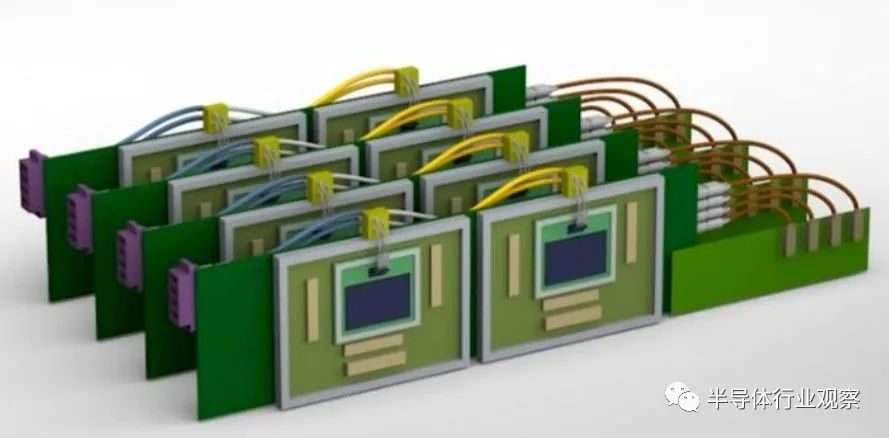
(圖源:英偉達)
英偉達正在集各方之力推動這一技術的實施。據台媒報道,業內消息人士透露,台積電參與了由Nvidia牽頭的研發項目,該項目將其稱為 COUPE(緊湊型通用光子引擎)的硅光子 (SiPh) 集成技術用於圖形硬件,以組合多個 AI GPU。
在2023年的OFC會上,Ayar Labs展示了業界首個4太比特/秒(Tbps)雙向波分複用(WDM)光學解決方案。而NVIDIA 的加速計算平台正是由WDM光學互連等先進技術支持,英偉達希望通過光互連為AI提供“下一個百萬倍”加速。Nvidia還參與了Ayar Labs去年的C輪融資,當時它籌集1.3億美元用於開發其帶外激光器和硅光子互連。兩家公司計劃共同加速光學I/O技術的開發和採用,以支持 AI 和機器學習 (ML) 應用程序和數據量的爆炸式增長。
光電共封技術商業化還有諸多挑戰
但是,光電共封技術要獲得大規模的商業化還需要解決多個挑戰,它必須可靠、可維修、可部署、可顯著節能並且具有成本效益。雖然光互連有望讓芯片間的帶寬達到更高水平,特別是在數據中心內部,但製造上的困難使其成本高昂到難以承受。
挑戰一,**CPO技術嚴重依賴於硅光子學技術,**需要將光學元件小型化以適應 ASIC 封裝(體積比傳統 QSFP-DD 或 OSFP 模塊小 100 多倍)。我們看到,專有的CPO方案首先出現在Broadcom、Intel、Marvell和其他一些公司,這些供應商大多已經收購或與創新的硅光子公司合作。他們在這一技術上的積累和努力,使得CPO的商業化漸漸成為可能。
另一方面,隨着光學和硅芯片的高度集成,新的工程能力和晶圓代工廠將是非常需要的。
在這方面,格芯是一個比較具有前瞻的代工廠。自從退出芯片先進製程的追逐後,格芯一直在探索其他技術,硅光子正是格芯押注大籌碼的一項技術。2015 年格芯收購了IBM Microelectronics 的一部分,因此也從IBM Research 獲得了光子學專業知識和知識產權。2016年,格芯就推出了其第一代硅光子平台,並在同年創建了一個獨立的硅光子業務。當時帶寬的行業標準是僅為40 GB/s。格芯打賭未來行業將不得不利用光的力量在全球各地湧現的數據中心內部和之間移動大量數據。事實證明,確實如此,如今數據中心的帶寬已來到400 GB/s和800 GB/s的數據速率。
**GF Fotonix 是格芯為硅光子芯片打造的一個整體的平台,這也是業界唯一的硅光子大批量 300mm CMOS製造代工廠。**根據格芯的介紹,該平台將光子元件與高性能CMOS邏輯和RF集成在一起,以實現完全集成的單片電氣和光學計算和通信引擎,同時針對低信號損耗降級進行了優化。此外,格芯單片硅光子平台的光輸入和光輸出可通過高密度光纖陣列、片上集成激光器和銅金屬化實現與其他半導體芯片的 2.5D 和 3D 異構集成。

芯片巨頭如Broadcom、思科、Marvell和NVIDIA以及Ayar Labs、Lightmatter、PsiQuantum、Ranovus 和 Xanadu 在內的光子計算領域的廠商都與格芯有着密切的交流合作。此外,EDA軟件廠商Ansys、Cadence和Synopsys等也正在提供支持基於集成硅光子學的芯片和小芯片的設計工具。
寫在最後
總而言之,光電共封的解決方案確實使得新一代的交換機與前幾代相比發生了很大的突破,但是如文中所述,CPO要成為主流還有諸多因素要克服,據Yole分析師的説法,儘管CPO具有技術優勢,但它將很難與可插拔模塊競爭,在很長一段時間內,可插拔模塊仍將是首選。可插拔、OBO和CPO將共存一段時間。
圖源:Yole
現在,光學器件可以與以太網交換機芯片共同封裝,未來,它能否與CPU、GPU或XPU集成在一起也或許是一個探究方向。在摩爾定律動力不足的情況下,光電共封這項技術正在嶄露其潛力,從另一條新道路上來滿足當下數據量蓬勃發展的處理需求。而且很重要的一個趨勢是,主要的芯片巨頭們都在排兵佈陣,光電共封技術正在向我們走進。