垂直GaN,還好嗎?_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。1小时前
**編者按:**最近,圍繞着垂直式GaN發生了很多新聞,例如去年年底,NextGen system的倒閉以及最近Odyssey semiconductor的清盤。這就不禁引發了大家的思考,垂直GaN未來還會好嗎?下面我們來看看這個技術的前景。
寬禁帶材料有望作為高功率效率的功率器件材料。特別是GaN、碳化硅(SiC)的技術開發和應用取得快速進展。橫向 GaN HEMT 已應用於耐壓 650V 以下的應用,例如用於 PC 的超小型交流適配器和超小型智能手機充電器,而垂直 SiC 溝槽 MOSFET 已應用於牽引逆變器(主電機驅動)等應用。應用於電動汽車(EV)耐壓1200V以上的應用,其社會化應用正在迅速加速。
雖然,氮化鎵(GaN)雖然非常適合作為功率器件材料,但由於難以生產高質量的襯底,直到現在才能夠展示其真正的潛力。但日本大阪大學教授 Yusuke Mori 先生正在致力於開發高質量、大直徑 GaN 襯底實現創新的二氧化碳減排。”根據迄今為止取得的成果,“釋放 GaN 作為功率器件材料的巨大潛力的準備工作正在穩步推進。”“它有取代碳化硅 (SiC) 的潛力,預計將在電路中找到更廣泛的應用。”
GaN 的潛力超過 SiC
如果我們使用 Barriga 指數來比較 MOSFET 和結型 FET (JFET) 等單極功率器件的整體適用性,該指數量化了 MOSFET 和結型 FET (JFET) 等單極功率器件的整體適用性,我們發現,當SiC在晶體多晶型為 4H時,指數為 500;而 GaN 則高得多,為 930。
Variga 品質因數是由電子遷移率 (μe)、介電常數 (ε) 和介電擊穿強度 (Ec) 等物理特性決定的值,原本 GaN 即使在耐壓 1200V 或 1200V 的應用中也優於 SiC。這表明它作為功率器件材料具有很高的潛力。如果能夠挖掘這一潛力,很有可能通過高頻工作使應用設備變得更小、更輕,進一步提高電源效率,提高應用設備的產量。
此外,在使用SiC基功率器件時,一直有人擔心可靠性問題,並希望應用GaN作為根本解決方案。SiC晶體有200多種類型,每種都有不同的堆疊結構和構成四面體晶體結構的四個最近的原子的排列,具體而言,主要包括“3C”、“4H”、“6”、“15R”這集中結構。
每種材料都有不同的物理特性,而4H具有高遷移率,專門用於許多功率器件。人們擔心的是,當器件在反覆加熱和冷卻的環境中使用時,可能會發生相變,導致器件質量發生變化,導致故障和失效。
當然,在使用SiC器件時,我們會通過改進器件結構、質量控制、驅動電路、運行條件、系統配置等措施來解決多態性問題。但可以肯定的是,如果能從物質本身消除引起焦慮的根本因素,就可以實現不依賴對症治療的根治。
對於GaN,則有其六方纖鋅礦結構和立方閃鋅礦兩種不同的結構。其中,前者是一種穩定相,用於器件製造;後者也是已知的,但它不是穩定相。這就是為什麼在需要高可靠性的應用中希望使用 GaN 代替 SiC。
儘管有這樣的背景,但 GaN 器件目前尚未用於處理大量功率的應用(例如電動汽車的牽引逆變器)是有原因的。為了應對高功率,需要將輸入端子和控制端子放置在類似於硅基MOSFET和IGBT(絕緣柵雙極晶體管)的半導體基板的正面,並將輸出端子放置在背面。創建一個允許大電流流過的垂直裝置。
此時,實現垂直GaN器件需要完全由GaN製成的自支撐襯底,但採用傳統的襯底製造技術,會出現許多穿透襯底並阻礙器件工作的位錯,不幸的是,質量還沒有達到可以滿足要求的水平。使垂直GaN器件的實現成為可能。
此外,為了實現可量產的垂直GaN器件,不僅需要提高襯底質量,還需要增大直徑,這直接導致器件製造成本的降低。最近,一些公司已經開始量產和銷售高質量的GaN自支撐襯底。例如,三菱化學已開始供應採用稱為氨熱法的液相晶體生長技術製成的 4 英寸襯底樣品,該技術允許高品質 GaN 晶體的高通量生長。
然而,行業人士認為,由於晶體生長的特性,使用氨熱法增加基板的直徑將被限制在約4英寸。需要實現技術突破來製造直徑更大的高質量獨立式 GaN 襯底。
垂直GaN,進展順利
垂直型氮化鎵(GaN)半導體的研發工作順利、且正朝着實用化邁進。
從2022年開始,松下HD和豐田合成分別研發了以下兩種計劃應用於EV逆變器的垂直型GaN功率半導體。其一為松下HD研發的垂直型Junction FET(JFET),該產品不僅有助於實現高頻工作設備的小型化、輕量化,且具有p-GaN柵(Gate)結構。其二為豐田合成研發的有望實現極高通用性的垂直型溝道MOSFET。

據瞭解,在該項目中,豐田合成引進了一種製造高質量、大直徑GaN襯底的技術,該技術結合了大阪大學開發的“Na助熔劑法”和“多點籽晶法”(圖1 ),開發一種可以生長8英寸以上大直徑晶體的裝置,並生產大直徑、缺陷密度為104 /cm2級的GaN籽晶。
Na助熔劑法是日本東北大學山根久典教授於1996年發明的,通過將鎵(Ga)和氮(N)溶解到液態鈉(Na)中來生長高質量GaN單晶的技術。由於它是液相生長,因此適合生產高質量的晶體。
另一方面,多點籽晶法是一種將許多小型GaN籽晶預先分佈在大型藍寶石襯底上,並在晶體生長過程中使生長的晶體熔合在一起的技術。利用該技術可以生產大直徑單晶。結合兩種方法的特點,將有可能生產出高質量、大直徑的GaN籽晶。
在藍寶石基板上製造GaN晶體的技術是應用多點晶種法的技術基礎,是豐田合成作為光器件技術而成熟的技術。因此,可以在量產水平上提高製造技術。
此外,“Na助熔劑法和多點籽晶法的組合非常兼容,進一步增加直徑沒有特別的障礙。目前,我們正在使用8英寸的晶種生產6英寸的晶種。“我們正在繼續開發該技術,未來我們還將考慮用 12 英寸藍寶石襯底生產 10 英寸 GaN 籽晶。”Toyoda Gosei 説道。
據透露,上述兩種器件均可耐650V高壓、20A電流,且計劃未來採用由“OVPE(Oxide Vapor Phase Epitaxy,氧化物氣相外延法)法”製成的GaN晶圓。該“OVPE法”由日本大阪大學、松下HD、豐田合成合作研發而成,利用該方法制成的GaN器件的ON電阻低於SiC一個數量級。

對於用於電動汽車逆變器等的垂直GaN器件,如果可以降低襯底的電阻,則可以降低器件的導通電阻,從而提高功率效率。通過在晶體中添加硅(Si)或氧(O)等元素可以降低GaN的電阻,但通過OVPE方法,可以生長添加更多的GaN晶體。可以形成電阻值低至10-4Ωcm 、超過SiC(10-3 Ωcm)、位錯密度低至10 4 /cm2的GaN晶體(圖3)。
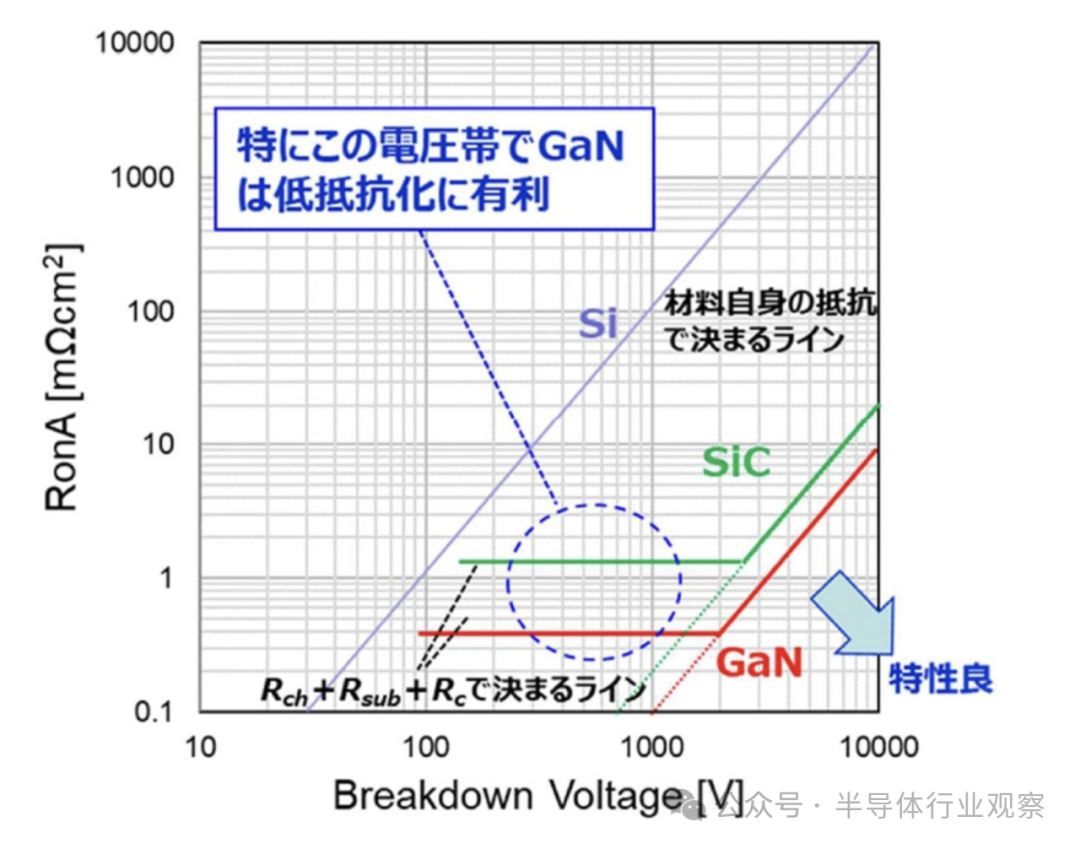
Panasonic HD 表示:“我們已經確認,可以使用 OVPE 方法在 2 英寸高質量 GaN 籽晶上製造超低電阻襯底。我們正在向豐田合成和我們的公司提供襯底。”作為環境部項目的一部分,我們正在開發垂直 GaN 器件。此外,在保持質量的同時,與傳統方法相比,我們使用 OVPE 方法將晶體生長速率提高了一倍。”
他們還已經證實,可以找到在使用OVPE法的晶體生長過程中,通過組合Na熔劑法和點晶種法制造的籽晶中殘留的夾雜物不破裂的條件。然而,“在實際量產中,有可能要求夾雜物為零。”我們將考慮解決這些問題的方法,我們還將在結合氨熱法制造的基板上使用OVPE。“我們還在試驗晶體生長技術,”Panasonic HD 説道。
日本名古屋大學有效利用上述試作品,並綜合考慮各試作品的靜態特性、動態特性,目前正在研發一款輸出功率為50kW的逆變器,該逆變器具有線路合理、工作條件和結構規格均出色的特點。其目標是在2025年應用於EV。未來,名古屋大學還將進一步提升輸出功率,同時,也在通過調整器件本身的結構,以研發出可耐1200V高壓的元件。
下一步是挑戰1200V的產品
據瞭解,由松下HD研發的p-GaN柵(Gate)結構的垂直型JFET特點如下,通過將柵(Gate)周邊調整為p-GaN/AlGaN/GaN,使常關閉(Normally-off)和低ON阻值成為了可能(下圖4)。電流流經路徑的一部分會形成與HEMT通道(Chanel)類似的二維電子氣(2D EG)。因此,易於降低ON阻值,更適用於高速工作。通過將此類垂直型JFET應用於高頻開關電源線路、電機驅動線路,不僅有利於提升功率,有利於實現電路中零部件的小型化(如線圈等)。
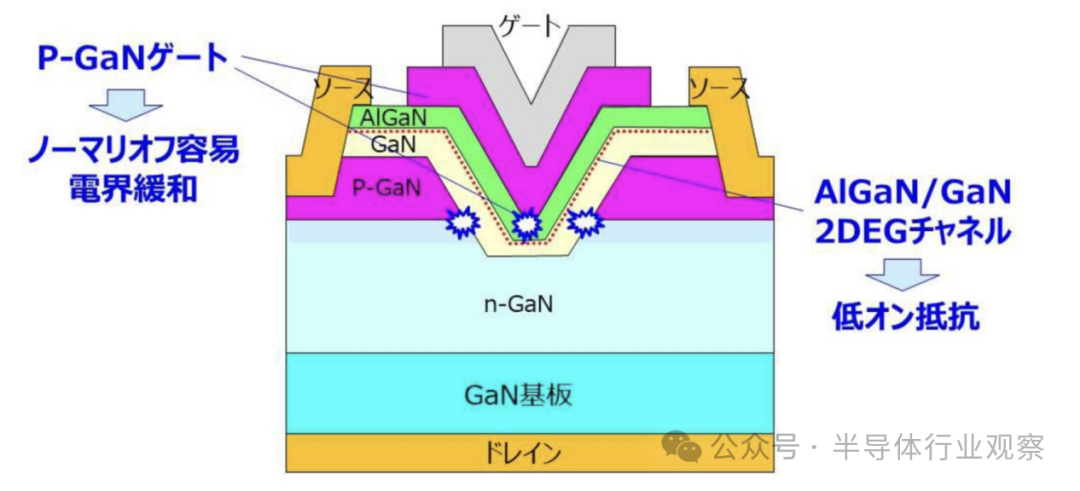
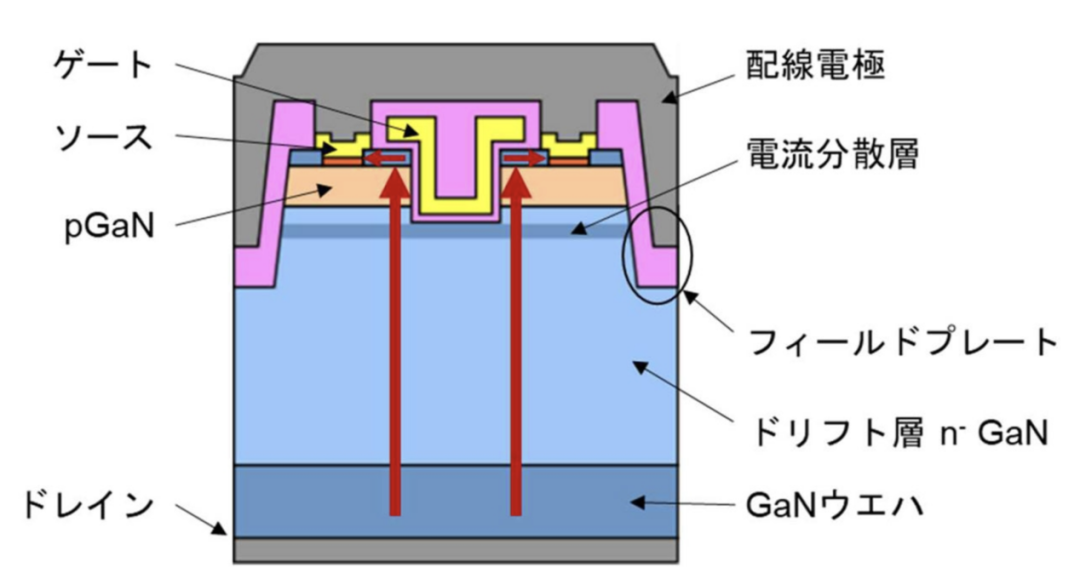
此外,松下HD 還利用柵部分的p-GaN來減輕電流阻擋層端部的電場,以降低電流的泄露。此外,10A試作品的實際驗證成果如下,閾值電壓為1.5V、RonA= 1.7mΩcm²、擊穿耐壓為600V以上。
由於GaN器件不會像Si、SiC一樣可通過熱氧化形成高質量的半導體和絕緣層界面,因此很難形成MOSFET結構,僅從這一點就阻礙了GaN器件的生產製程。但是,松下HD研發的GaN為JFET結構,不需要形成氧化膜。
如今,用於PC方向超小型AC適配器等設備的橫向型HEMT結構的GaN功率器件也由同樣的工藝製成,因此,可在現有的GaN器件的工廠內生產。此外,不同於柵極由電壓驅動的MOSFET,JFET由電流驅動。雖然驅動IC等周邊電路的配置不同於Si、SiC,但就這一點而言,有利於橫向型器件的技術積累。(松下HD)
為儘快實現實際應用,松下HD還評價了其研發的器件的可靠性和熱阻。為進一步改善此次試做的器件,松下HD還進行了短路耐受測試、連續開關測試,並找到了一些課題。利用OVPE法形成的GaN層雖然可以降低電阻、減少發熱,但也存在熱阻較高,不易散熱的問題。為了發揮OVPE法應用的優勢,需要考慮更改器件的設計、或針對封裝(Package)開發出新的散熱手段,以避免對器件的工作造成不良影響。
松下HD還在研發可耐1200V以上高壓的垂直型GaN器件,並討論了可降低碳(C,此處為隨機進入漂移(Drift)層,並補充施體(Donor)的碳)濃度的結晶生長條件,同時還發現了可將碳濃度控制在5×1015/cm3以下的漂移(Drift)層的生長條件,以促進GaN器件的製作。為了今後穩定生產高耐壓垂直型GaN器件,還需要研發出可進一步降低碳濃度的結晶生長技術。
豐田合成研發的溝槽(Trench)MOSFET基本上採用了與Si基、SiC基垂直型溝槽MOSFET同樣的結構(下圖4)。豐田合成的工藝如下,在GaN晶圓上同時外延生長出漂移層(n-GaN層)、Body層(pGaN層)、源接觸層(Source Contact,n+GaN層)。豐田合成的工藝不使用離子注入來製作pGaN層,因此製程相對簡單。
隨後,用幹蝕刻加工了接觸區域的凹槽(Recess)、柵極溝槽(Gate Trench)。豐田合成特意採用了原子層沉積法,以使形成柵極溝槽的柵極絕緣膜的厚度、性質更均一。其MOSFET特性如下,一顆芯片排列有數十萬個六角形的MOSFET單元。當需要對應較大的電流時,可通過增加單元數量來滿足。
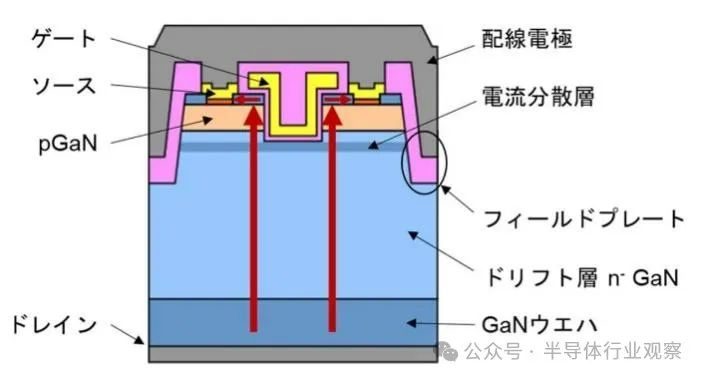
MOSFET的特點在於它比JFET更容易實現常關動作(Normally-off),這對確保信賴性十分重要。此外,MOSFET的另一個優勢是,可基於更微縮化的技術實現更高的性能。另外,MOSFET需要滿足以下應用要求,如在某些應用中(如汽車等),需要滿足與傳統器件的兼容性,同時採用傳統的器件的結構、或採用類似於現有技術的線路佈局,而不是單純的提升性能。
如上文所述,豐田合成已經制成了可評價650V、20A基本性能的測試樣品。“即使不使用基於OPVE法制成的超低電阻GaN晶圓,也可獲得性能不低於SiC的垂直型GaN MOSFET。未來,可基於OPVE法進一步提升性能。(豐田合成)”日本環境省的項目中提到,在2025年實現50Kw級別的逆變器,且計劃將650V耐壓器件的額定電流提升至60A。如果今後需要將輸出功率提升至100Kw,則需要考慮研發1200V耐壓的器件。
商業化很快了?
雖然研發成果“喜人”,但量產之路似乎還比較漫長。據豐田合成表示,晶圓的平整度(SFQR:Site Front least sQuare Range)與工藝的良率存在相關性。豐田合成選擇了平整度較好的晶圓,不僅實現了器件本身的大尺寸化、還使器件可滿足更大的電流,據悉,豐田合成試做了一款可耐650V高壓、20A電流的垂直型溝槽式MOSFET。豐田合成的此次研發項目優勢明顯,即及時將驗證結果反饋到晶圓的研發中,提升了從晶圓到芯片的研發速度。
此外,日本名古屋大學在對上述樣品進行測試後發現了以下問題,在開關操作期間,ON電阻急劇增大。豐田合成調查後發現,pGaN中鎂元素(Mg)的濃度與名古屋大學指出的問題有一定關聯性,並且,上述問題在高電流負載條件下尤其明顯。由於需要保持常關動作(Normally-off),因此不能大幅度調整鎂元素(Mg)的濃度。未來豐田合成將研發其他解決方案。
在實現1200V以上耐壓的研發工作中,松下HD的JFET面臨着同樣的問題,即難以控制漂移層中雜質的濃度。
一方面,有不少企業在研發可與SiC器件匹敵的垂直型GaN器件,同時也有不少企業在研發能夠使橫向型GaN FET在更高電壓條件下工作的技術。據悉,豐田合成在研發一種名為“極化超結合結構(Polarization Super Junction,PSJ)”的技術,該技術基於HEMT結構,在通道區域形成GaN/AlGaN/GaN的異質鏈接。據悉,利用PSJ技術,有望獲得耐一萬伏特高壓的器件,而通常是通過SiC MOSFET、Si IGBT來實現耐超高電壓的。
與HEMT結構相比,PSJ結構的GaN FET的開關頻率較低,但仍可支持數MHz的工作,耐壓水平不僅超過SiC器件,開關頻率也遠高於SiC MOSFET(上限數為數百kHz)、Si IGBT(數十kHz)。如果使用比GaN自支撐晶圓更經濟、絕緣性更出色的藍寶石晶圓(GaN on Sapphire)的話,橫向型器件的上市時間有望早於垂直型GaN。
當然,如果未來研發的用於垂直型GaN的低阻值、高質量GaN自支撐晶圓的技術能夠被應用於絕緣性晶圓,那麼具有高耐壓、高性能的“GaN on GaN”PSJ器件的市場需求可期。豐田合成指出:“隨着PSJ結構的外延層(epi)、工藝技術的進步,GaN on Sapphire的性能、信賴性也會遠高於最初的設想。在穩步推進GaN自支撐晶圓、垂直型GaN的研發的同時,我們期望驗證基於GaN on Sapphire的PSJ器件的特性和實用性,並評估儘早進入GaN功率半導體市場的可能性。”