混合鍵合,會取代TCB 嗎?_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。42分钟前
在摩爾定律事實上失效了以後,過往在單芯片上通過改善工藝製程來推高芯片性能的方式逐漸成為了過去式。取而代之的是各種先進封裝技術,用各種“拼接”的方式去推高芯片的性能。這種趨勢一個典型的範例就是GPU芯片巨頭英偉達在最新的B200上的實踐。
作為單芯片最忠實的支持者,英偉達過去多年裏一直都是通過工藝和架構改善來提高芯片的性能,然而在B100上,英偉達也事實上採用了行業主推的Chiplet設計方式,用自有的NV-HBI(Nvidia High Bandwidth Interface)把兩個突破了reticle極限的兩個芯片連接起來,按照technews所説,在這背後倚仗的是台積電的CoWoS先進封裝工藝。
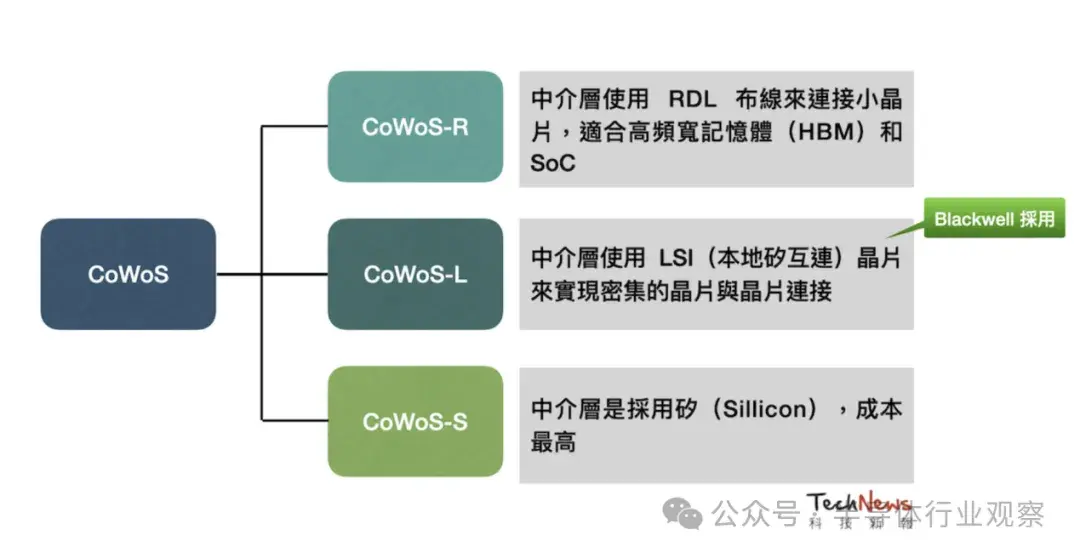
例如TCB(Thermocompression bonding)和混合鍵合(hybrid bonding)會如何發展?
TCB,尚能飯否?
在詳談TCB之前,我們先對先進封裝進行一個定義。其實關於什麼是先進封裝,不同行業有不同的定義,Semianalysis的分析師Dylan Patel就把所有凸塊尺寸(bump size)小於 100 微米的封裝稱為“先進封裝”。
他在文章中進一步指出,最常見的先進封裝類型稱為扇出型封裝(Fan-out),在蘋果公司將其應用到其A系列手機芯片後廣為大眾熟知。與傳統倒裝芯片封裝相比,蘋果芯片封裝的凸塊密度(bump density)大約高出 8 倍。而從構造上,除了常規的封裝,現在先進封裝有2.5D和3D封裝。
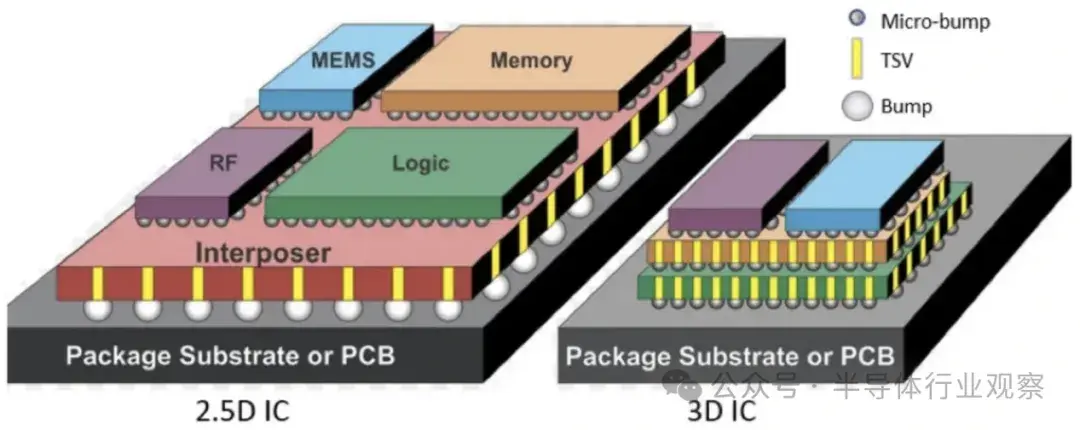
目前,2.5D是更多芯片廠商的首選。例如英偉達的H100 GPU採用的就是2.5D封裝中最常見和產量最高的TSMC CoWoS(chip on wafer on substrate)。在這個封裝方法中,台積電將把有源芯片封裝在只有互連和微凸塊的晶圓頂部,然後使用傳統方法將這堆芯片封裝到基板上。近年來大火的HBM則屬於2.5D封裝的另一個典型範例,在其生產過程中也使用了本章節我們討論的技術重點——TCB。
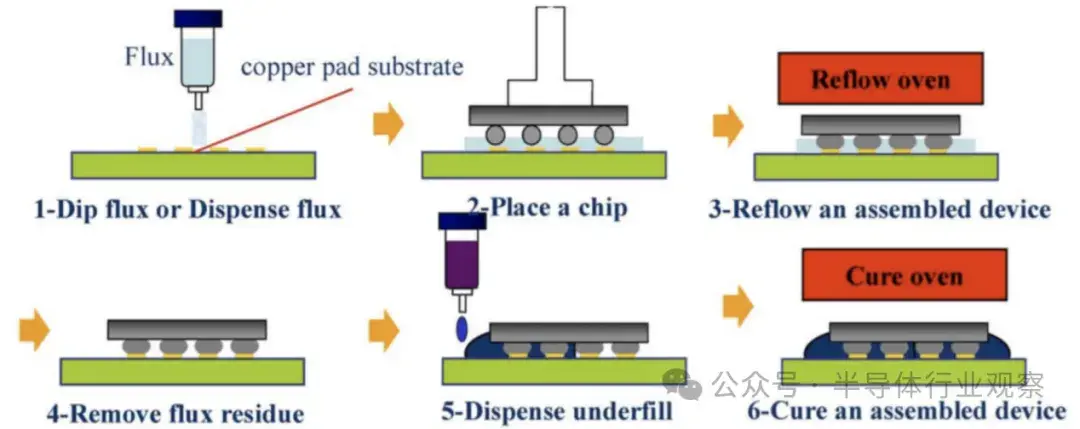
相關資料介紹,熱壓鍵合主要用於創建原子級金屬鍵合。它利用力和熱量來促進原子在晶格之間遷移,從而形成清潔、高導電性和堅固的鍵合。通常,TCB被用於垂直集成器件的 CMOS 工藝、金引線和表面之間固態鍵合的順應鍵合(compliant bonding)、用於將芯片凸塊鍵合到基板的倒裝芯片應用以及用於連接微型組件的熱壓鍵合。
因為其應用的領先型,在發佈了以後,這類封裝的需求也很大。這個技術也在過去幾十年裏也一直在封裝市場“呼風喚雨”,即使在文章開頭談到的HBM,無論是三星、SKHynix 和美光供應的產品,都也使用了TCB技術。
作為一種創新型的DRAM,HBM在過去幾年大放異彩。就連英偉達CEO黃仁勳在日前舉辦的GTC大會上談到HBM的時候,也直説這是一個技術奇蹟。
從技術層面上看,HBM的為了將內存帶寬提高到傳統 DRAM 之上的一種方式。它通過使用更寬的內存總線來實現這一點。這些寬總線會產生與 IO 計數相關的問題,但 HBM 是從頭開始設計的,可以在同一封裝內共存,就這顛覆了 IO 問題,同時還允許更緊密的集成。
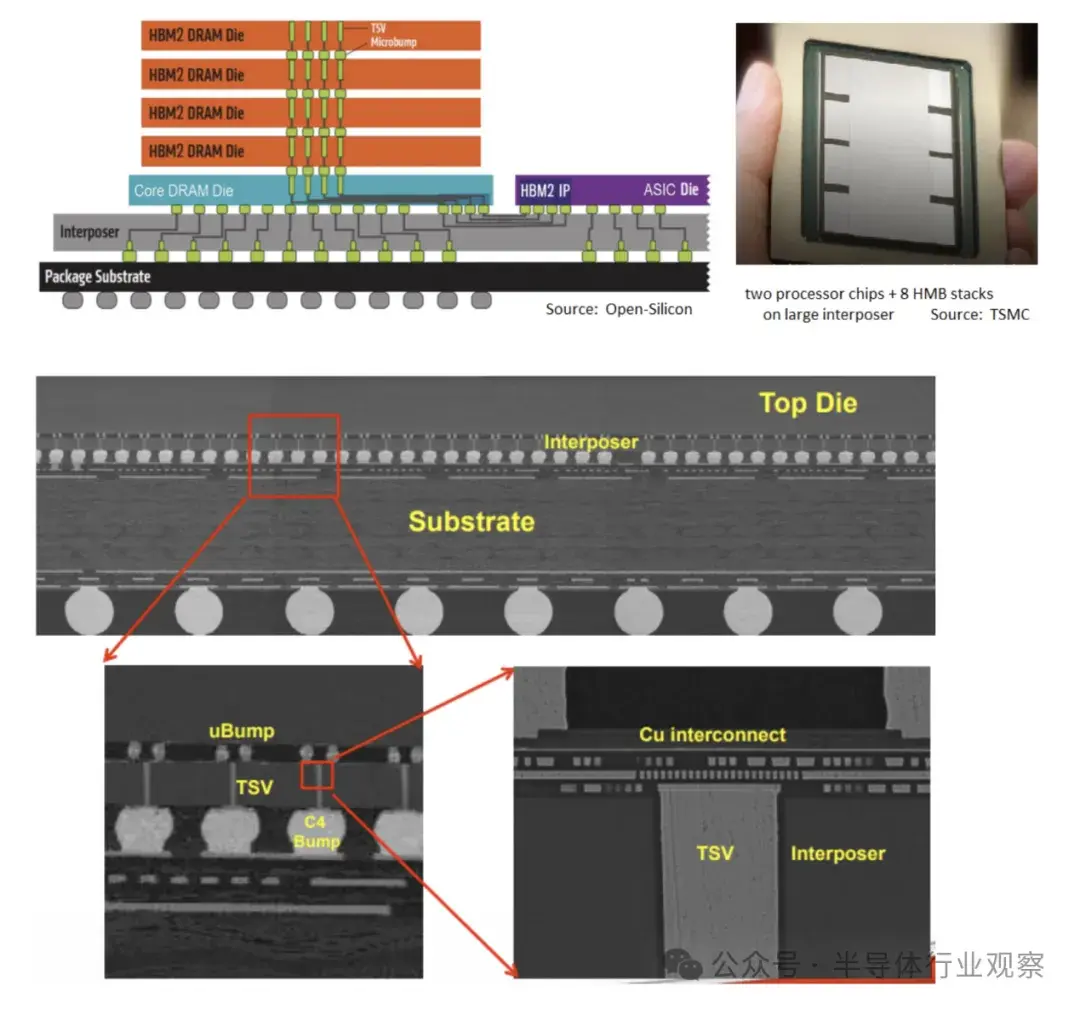
“在相同的 IO 間距下,TCB可實現更好的電氣性能。TCB 還允許 IO 間距縮小到更小的尺寸。TCB 還可以封裝更薄的dies和封裝。後者正是是HBM使用TCB的原因。與標準倒裝芯片工藝流程相比,TCB 似乎是一種更好的技術,”Dylan Patel接着説。
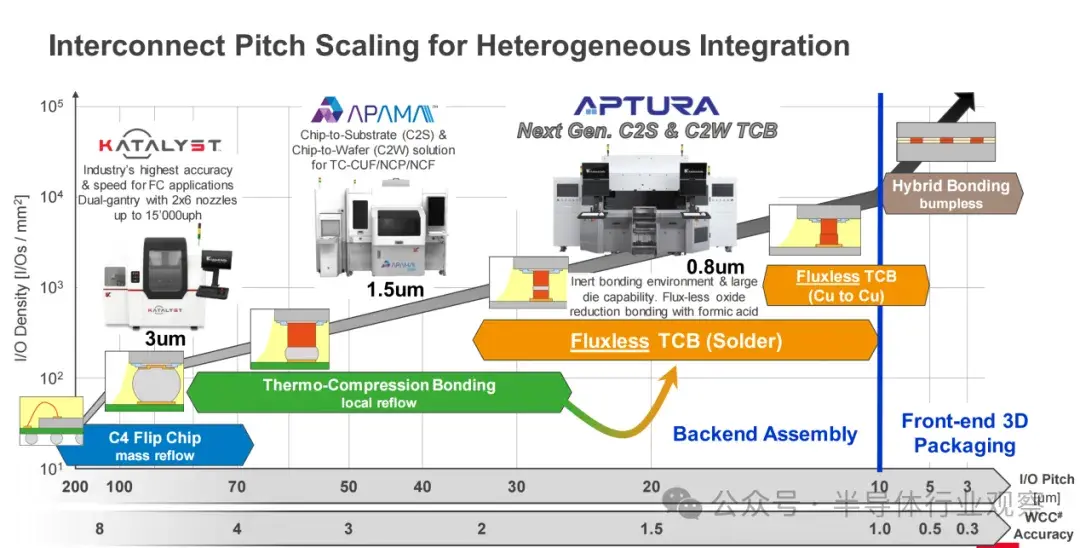
以HBM為例,張贊彬表示,目前HBM有兩種實現方法:一個是用傳統的flip chip去封裝。另外一個是用TCB。其中前一種會一直存在,但如果需要温度控制,就用TCB。同時,因為HBM堆疊的die需要非常薄,所以直到現在最先進的12堆棧HBM,依然是使用了TCB技術。“從目前看來,下一代的16堆棧HBM,依然會使用TCB工藝。”張贊彬告訴筆者。
Dylan Patel在其文章中披露,Intel的大部分封裝技術也使用TCB,併成為了TCB的堅定支持者,英特爾在許多封裝應用中使用 TCB。又因為 TCB 是封裝極薄芯片的最佳技術,因此 TCB 也在使用 OSAT 和 IDM 封裝的旗艦設備中的手機應用中進行了試驗。三星、高通/Amkor 也已在一些與層疊封裝 (PoP) DRAM 相關的應用中使用了 TCB,OSAT也開始訂購越來越多的 TCB 工具。
但正如Dylan Patel所説,廠商正在轉向更神奇混合鍵合技術。
混合鍵合,未來可期
根據Dylan Patel的觀點,封裝行業最後一次重大範式轉變是從引線鍵合到倒裝芯片。從那時起,更先進的封裝形式(例如晶圓級扇出和 TCB)一直是相同核心原理的漸進式改進。這些封裝方法都使用某種帶焊料的凸塊作為硅與封裝或板之間的互連。而這些技術可以一直縮小到約 20 微米的間距。
“但是,為了進一步擴展,我們需要另一種範式轉變:採用混合鍵合的無凸塊互連的混合鍵合,其尺寸超出了 10 微米互連間距,路線圖為 100 納米範圍,並且它不使用任何中介物,例如具有更高電阻的焊料。”
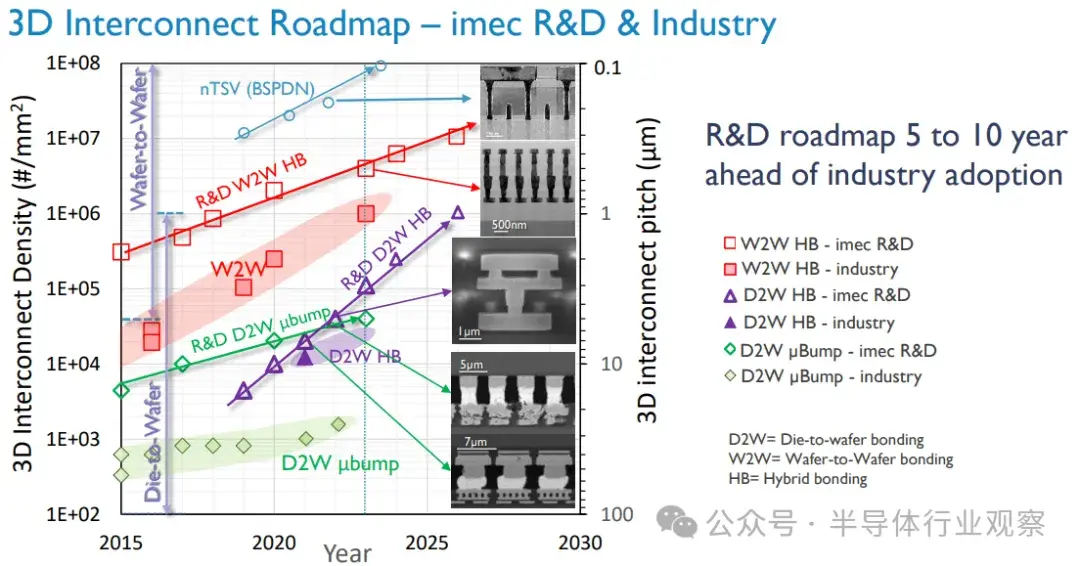
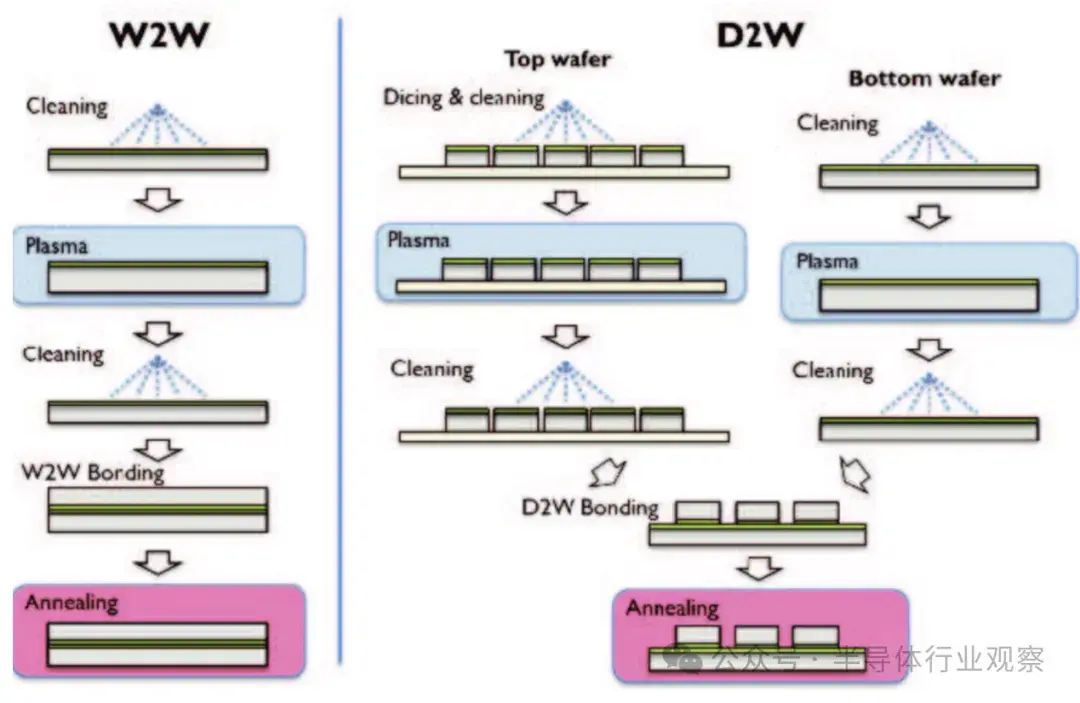
與微凸塊(microbumps)相比,過渡到混合鍵合的原因相當簡單。那就是3D 內存堆棧和異構集成(超越摩爾時代的兩個參與者)需要極高的互連密度,如上所述,混合鍵合可以滿足這一需求;與本身支持高密度互連方案的微凸塊相比,混合鍵合可提供更小尺寸的 I/O 端子和減小間距的互連。每個芯片之間的間隔距離取決於微凸塊的高度,但在混合鍵閤中該距離幾乎為零。
因此,混合鍵合互連方案可以顯著降低整體封裝厚度,在多芯片堆疊封裝中甚至可能高達數百微米。為此,自十多年前在 CMOS 圖像傳感器中首次亮相,混合鍵合逐漸走向了3D NAND,甚至連DRAM和HBM,也對混合鍵合產生了興趣。今年二月更是有消息傳出,英特爾下一代 Xeon“Clearwater Forest”CPU 採用一個名為“Foveros Direct”的混合鍵合的3D 堆疊技術。
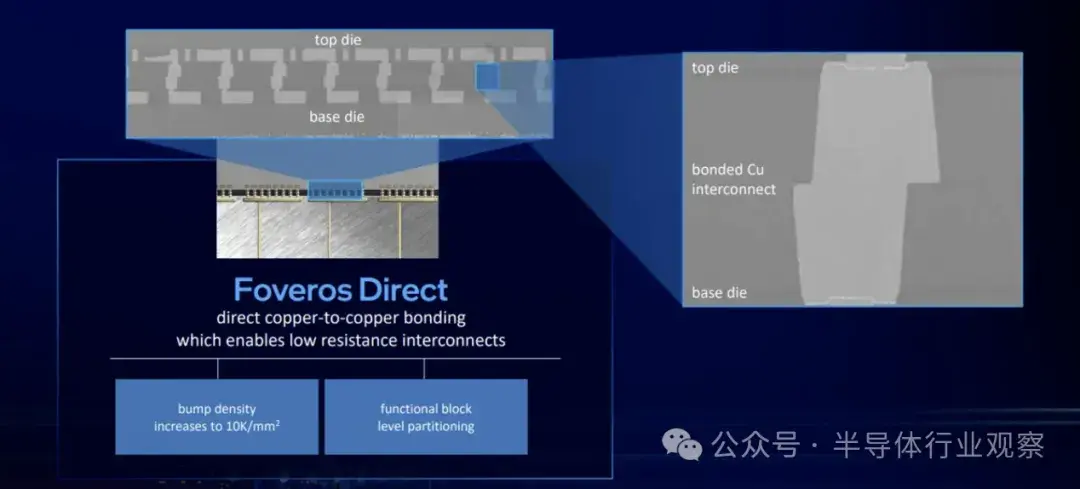
“Hybrid Bonding是針對微納米這種高端工藝的,這種技術不是每一種產品可以應用,因為它的價格和成本都很高,所以我覺得幾種高端產品會有這種應用,大部分的芯片還是會用到傳統的方法。”張贊彬説。他指出,和TCB是一個後段製程不一樣,混合鍵合某種程度上是一個前道工藝,所以這帶來的挑戰也是顯而易見的。
“混合鍵合對環境要求非常高,要達到class 1 clean room(非常的清潔),這是為什麼現在目前投資Hybrid Bonding的大部分客户都是前端的客户,因為他們有前端的製程、設備和環境,所以可以擴大Hybrid Bonding。但是一個傳統的封裝廠如果想切入這個領域,則要做一個大投資,要做非常清潔的Clean room,這樣的話門檻就提高了很多。這也是為什麼打線機今天還那麼受歡迎,因為在封裝這方面是最實際、最便宜的方法。”張贊彬解析説。
最近的一則新聞,也讓混合鍵合遭受了打擊。
在去年12月舉辦的IEDM 2023上,SK海力士宣佈,其已確保HBM製造中使用的混合鍵合工藝的可靠性。消息表示,HBM 芯片的標準厚度為 720 µm。預計將於 2026 年左右量產的第 6 代 HBM(HBM4)需要垂直堆疊 16 個 DRAM,這對當前的封裝技術滿足客户滿意度來説是一個挑戰。因此,Hybrid Bonding工藝在下一代HBM中的應用被業界認為是必然的。
但是,早前有消息透露,國際半導體標準組織(JEDEC)的主要參與者近日同意將HBM4產品的標準定為775微米,那就意味着HBM開發者使用現有的鍵合技術就可以充分實現16層DRAM堆疊HBM4。
不過,這應該不會阻擋廠商們投入這個賽道。據瞭解,包括台積電、英特爾、三星、SK海力士、美光、索尼、豪威科技、鎧俠、西部數據、Besi、芝浦電子、東京電子、應用材料、EV Group、SUSS Microtec、SET和博世等廠商都對混合鍵合產生了興趣。
甚至連TCB解決方案的主要供應商Kulicke & Soffa加入了混合鍵合陣營,對這個技術進行了預研,並認為這個技術在未來某個時刻迎來新的機會。
設備廠商,見招拆招
雖然有波折,但先進封裝前進的道路是不可逆轉的。
行業諮詢機構Yole在去年年底發佈的報告中表示,預計先進封裝市場在 2023 年將下降 1.4%,但2023年Q3,先進封裝(AP)營收較上季度大幅增長23.7%,總計達到110億美元。
Yole進一步指出,在未來幾年,先進封裝收入預計將以 8.6% 的複合年增長率增長,從 2022 年的429億美元增長到 2028 年的704億美元。就收入而言,倒裝芯片 BGA、倒裝芯片 CSP 和 2.5D/3D 是主導封裝平台,其中 2.5D/3D 技術顯示出最高的增長率,預計將從 2022 年的94億美元增長到 2028 年的225億美元,複合年增長率為 15.6%。

首先看Kulicke & Soffa,如上所述,他們現在這個階段應該是非常看好TCB,在去年8月,他們曾經發布新聞稿表示,將擴大與UCLA CHIPS的合作,開發超細間距微凸塊互連解決方案。按照他們在當時的新聞稿所説,不久之後,30μm 微凸塊間距的熱壓接合 (TCB) 變得可行。通過利用甲酸處理(By leveraging formic acid treatment),K&S 在 TCB 中展示了 10μm 間距的能力。雙方的合作則旨在進一步開發可製造的銅對銅解決方案,將其間縮小至 5μm以下。
ASMPT 首席執行官Robin Ng在接受媒體採訪的時候則表示,他將於今年下半年開始向客户提供混合鍵合機。Ng 表示,當混合鍵合芯片系統封裝的大規模生產真正起飛時,ASMPT 已準備好交付機器。他進一步指出,ASMPT將大幅增加先進封裝的研發預算,包括熱壓鍵合、光子學和混合鍵合。
而作為混合鍵合機市場的激進玩家,Besi的首席執行官Richard Blickman在介紹年度業績時透露,截止2023年,除了三名現有客户外,公司還為這些混合鍵合機器贏得了六名新客户,Besi 也有 40 多套混合鍵合系統現已投放市場。
相關資料顯示,英特爾和台積電是 Besi 的主要客户,但他們對內存市場寄予厚望。例如HBM,就是Besi 最看好的方向,但目前他們只有美光一個客户。據Richard Blickma預計,內存市場不會為第一代 HBM4 部署混合鍵合,第二代的可能性更大。
另一家設備供應商EV Group則為NAND 市場提供設備,以實現晶圓對晶圓混合鍵合工藝。
寫在最後
在分析人士看來,未來許多封裝技術將並列使用。而且混合鍵合不會取代 TCB,而是會互相補充。
目前,蘋果、AMD、英偉達和英特爾等系統開發商正在研究這兩者,代工廠以及邏輯和存儲器製造商將採用這兩種互連選項的比例還有待觀察。不同客户的情況也可能有很大差異。例如,AMD 已經在其微處理器中使用混合鍵合,而 Nvidia 則選擇了 TCB。這兩種技術仍在開發中。
如果間距降至 25 微米以下,混合鍵合無疑是一個重要的選擇,但它更昂貴。
總之,技術總是在進步,我們總能看到解決的方法。