讓台積電捏了把汗的技術,終於成熟?_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。43分钟前
2011年的台積電第三季法説會上,張忠謀突然拋出了一個重磅炸彈─台積電要進軍封裝領域。
台積電所推出的第一個封裝產品,就是CoWoS(Chip on Wafer on Substrate),其將邏輯芯片和DRAM放在硅中介層(interposer)上面,然後封裝在基板上。張忠謀表示,未來台積電的商業模式將是提供全套服務,實現整顆芯片的生產製造。
2016年,英偉達推出了第一款採用CoWoS封裝的圖形芯片GP100,為第一波人工智能熱潮拉開序幕,而後,谷歌AlphaGo打敗柯潔背後的TPU 2.0,所用到的CoWoS封裝同樣出自台積電之手。
時至今日,CoWoS已成為AI芯片繞不過去的一項技術,而先進封裝也已深入半導體行業,成為不遜色於先進製程的一個熱門領域。
但對於拋出了Foundry 2.0的台積電來説,光靠CoWoS顯然是有些不夠的,尤其是考慮到它的產能有限,甚至無法滿足英偉達需求的情況下,它亟需推出更多更好的封裝產品。
而當我們放眼整個先進封裝市場之際,會發現除了過去一年中熱議的2.5D和3D封裝外,有幾項新技術被提到的次數愈來愈多,AI芯片帶火了CoWoS,如今它又把先進封裝中的FOPLP和玻璃基板帶上了舞台。
搶灘FOPLP
為何扇出型面板級封裝(FOPLP)成了廠商的香餑餑?
2016 年,台積電着手開發名為 InFO(整合扇出型封裝)的 FOWLP(扇出型晶圓級封裝)技術,用於 iPhone 7 系列手機的 A10 芯片上,將三星代工廠擠出了蘋果供應鏈,而後封測行業紛紛跟隨台積電的腳步,開始推廣 FOWLP 方案,希望以更低的成本吸引客户。
但在幾年過後,FOWLP 封裝方案在技術方面沒有太大的突破,終端應用方面依然停留在 PMIC(電源管理 IC)等成熟工藝產品上,難以敲開更多客户的大門。
此時FOPLP登上舞台,從wafer level(晶圓級)切換到 panel level(面板級),兼具低單位成本和大尺寸封裝的優勢,也引發了AI芯片廠商的關注。
晶圓級封裝和麪板級封裝之間的主要區別在於,前者不是將切割的芯片重新組裝在晶圓上,而是將它們重新組裝在更大的面板上。這使製造商能夠封裝大量芯片,從而降低封裝過程的成本。它還提高了封裝效率,原因是通過方形基板進封裝,可使用面積可達圓形12英寸晶圓的7倍之多,即在相同單位面積下,能擺放更多的芯片。
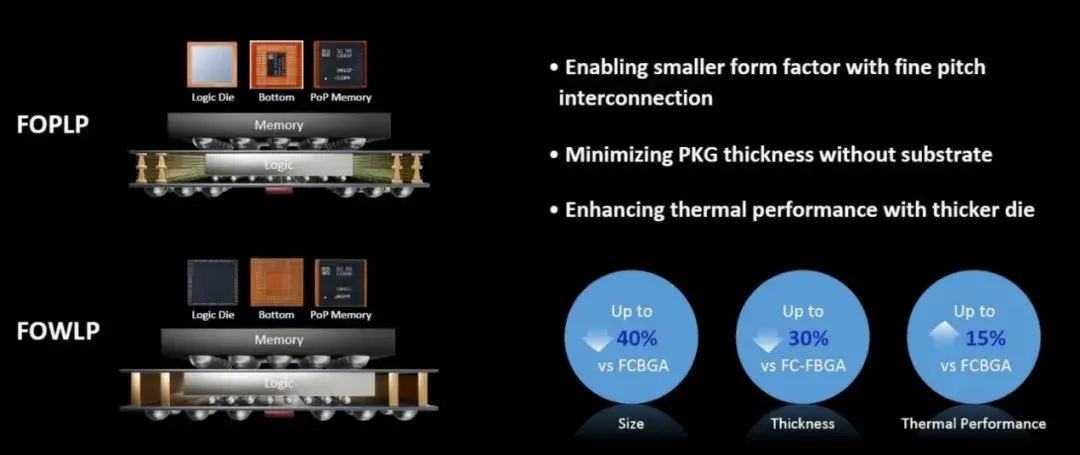
值得一提的是,這一新興市場的增長速度非常快。Yole Group 半導體封裝分析師 Gabriela Pereira 表示:“縱觀整個扇出型封裝市場,FOWLP 仍然是主流載體類型,而 FOPLP 仍被視為小眾市場。在收入方面,Yole Intelligence 在《扇出型封裝 2023》報告中估計,2022 年 FOPLP 市場規模約為 4100 萬美元,預計未來五年將呈現 32.5% 的顯着複合年增長率,到 2028 年將增長至 2.21 億美元。
事實上,FOPLP 的採用將比整體扇出型市場增長更快,其相對於 FOWLP 的市場份額將從 2022 年的 2% 上升至 2028 年的 8%。這意味着,隨着更多面板生產線的推出以及更高的良率帶來更好的成本效益,FOPLP 有望在未來幾年實現增長。”
而最新的利好是,英偉達有意將面板級扇出型封裝(通常稱為 FOPLP)用於最新 Blackwell 芯片,英偉達為Blackwell 產品提供的 CoWoS封裝產能緊張,有傳言稱 Blackwell GB200 也可能提前於明年(2025 年)開始使用 FOPLP,而不是最初的 2026 年時間表。此外,AMD也已經開始接觸相關企業,準備在未來的AI芯片中採用FOPLP。
而與此相對應的是,是一眾中國台灣封測企業正在加速開發FOPLP。
台灣半導體封測廠中最早投入佈局FOPLP量產線的是力成,於16年在竹科三廠開始興建全球第一座FOPLP生產線,19年正式啓用量產。力成執行長謝永達説,力成領先業界約2年左右,看好未來在AI世代中,異質封裝將採用更多FOPLP解決方案,預期26、27年陸續開花結果。
羣創利用不具有價值的3.5代廠設備進行轉型,其中近7成的設備可以延續使用,是目前面板尺寸最大的生產線。羣創投入研發FOPLP的時間也已經長達8年,其中不只取得經濟部大A+計畫的補助,也與工研院合作,預計今年第四季將正式導入量產,明年對於營收將帶來1至2個百分點的貢獻。
根據研究機構TrendForce的調查,在FOPLP封裝技術導入上,三種主要模式包括:一,封測代工業者將消費性IC封裝方式自傳統封裝轉換至FOPLP。二,專業晶圓代工廠、封測代工業者封裝AI GPU,將2.5D封裝模式自晶圓級轉換至面板級。三,面板業者鎖定電源管理、消費性IC等應用。
而大廠的動作也相當迅速。台積電董事長魏哲家首度在近期法説會上説明FOPLP佈局的進度,台積電已成立研發團隊與產線,目前仍處於起步階段,他預期三年後技術可成熟,屆時台積電將具備量產能力。
緊接着在日月光投控的法説會上,營運長吳田玉表示,日月光在面板級的解決方案上已經研究超過5年,先從300mm×300mm開始,未來會擴展到600mm×600mm的尺寸。
而在中國台灣之外,韓國的三星也在緊鑼密鼓地推進FOPLP封裝技術。
早在8年前,三星電機就為Galaxy Watch開發了 FOPLP 技術,並於 2018 年開始量產,而在2019年,三星電子以 7850 億韓元(約合 5.81 億美元)從三星電機手中收購了 PLP 業務,截止目前,Galaxy Watch 6 芯片依然沿用該技術,利用 FOPLP 結合封裝堆疊 (PoP) 技術將 CPU、PMIC 和 DRAM 集成到芯片組中。
三星電子半導體(DS)部門前主管 Kyung-Hyun Kyung 在今年 3 月份的公司股東大會上解釋了對 PLP 技術的需求。他説:“AI芯片基板的尺寸通常為 600 mm x 600 mm或 800mm x 800 mm,這就需要 PLP 等技術。”他還補充説:“三星電子也在開發並與客户合作。”
三星目前為需要低功耗存儲器集成的應用(如移動和可穿戴設備)提供 FOPLP,其還計劃將其 2.5D 封裝技術 I-Cube 擴展到 PLP。
相較於台積電和三星,英特爾在FOPLP上顯得沒那麼熱衷,儘管它也具備相關技術儲備,但就目前而言,它還沒什麼FOPLP領域的大動作。
值得一提的是,台積電目前由於訂單爆滿,已經開始大規模擴建已有的封裝廠,甚至不惜以高價購買其他公司的封裝廠,以滿足客户的需求。
今年8月,台積電宣佈以約5.28億美元的價格買下了羣創南科5.5代面板廠(南科四廠)及附屬設施,並預定11月成交。根據公告,該廠建物面積約摺合9.6萬餘坪,據瞭解,雙方洽談購買將不僅南科四廠,而是會有兩個廠,並傳接下來交易的可能是羣創南科五廠。
台積電開出的設備採購清單中,已見編列AP八的編號,意謂繼嘉義廠的AP七興建兩座封裝廠後,羣創南科舊廠將是下一個先進封裝據點,並規劃明年第一季開始裝機,依時程可能比嘉義新廠早一步投入,支持最缺的CoWoS產能;後續第二座廠,羣創可能屬意與台積電共同合作FOPLP。
在大廠這裏,FOPLP已成了必爭之地,但對於AI芯片來説,光有這項封裝技術還不夠。
玻璃基板競賽
為什麼FOPLP需要玻璃基板?
FOPLP的特點是採用了更大的基板,但傳統的塑料基板在IC越來越多越來越大的情況下,容易出現翹曲的問題,伴隨着眾多封裝廠商開始用大尺寸基板,這一問題愈發突出。
除了翹曲外,塑料基板(有機材料基板)也在不斷接近達到容納的極限,特別是它們的粗糙表面,會對超精細電路的固有性能產生負面影響,在這樣的情況下,玻璃作為一種新型基板材質,走入了半導體行業。
作為新型方案,玻璃基板有比塑料基板更光滑的表面,同樣面積下,開孔數量要比在有機材料上多得多。據悉,玻璃芯通孔之間的間隔能夠小於 100 微米,這直接能讓晶片之間的互連密度提升10倍。互連密度的提升能容納的更多數量的晶體管,從而實現更復雜的設計和更有效地利用空間;
同時,玻璃基板在熱學性能、物理穩定度方面表現都更出色,更耐熱,不容易因為温度高而產生翹曲或變形的問題;此外,玻璃芯獨特的電氣性能,使其介電損耗更低,允許更加清晰的信號和電力傳輸,與ABF塑料相比,玻璃芯基板的厚度可以減少一半左右,減薄也可以提高信號傳輸速度和功率效率。
但玻璃基板並非沒有缺點。玻璃板的厚度通常為 100µm 或更薄,在運輸、處理和製造過程中容易因壓力而開裂或破碎,需要專門設備和工藝來使用和管理這種材料。
此外,玻璃基板面臨的一個重大障礙是缺乏統一的玻璃基板尺寸、厚度和特性標準。與遵循精確全球規格的硅晶片不同,玻璃基板目前缺乏普遍接受的尺寸和特性。標準化的缺陷使廠商在不對工藝進行重大調整的情況下更換基板的半導體工廠的問題變得複雜。與之密切相關的是兼容性問題,不僅是不同批次的玻璃基板之間的兼容性,而且還有基板與其支持的半導體器件之間的兼容性,玻璃獨特的電氣和熱性能必須與半導體器件的電氣和熱性能進行仔細匹配。
玻璃基板的特性讓行業趨之若鶩,但所帶來的技術挑戰又勸退了許多中小型企業,只有幾位巨頭願意當第一個吃螃蟹的人。
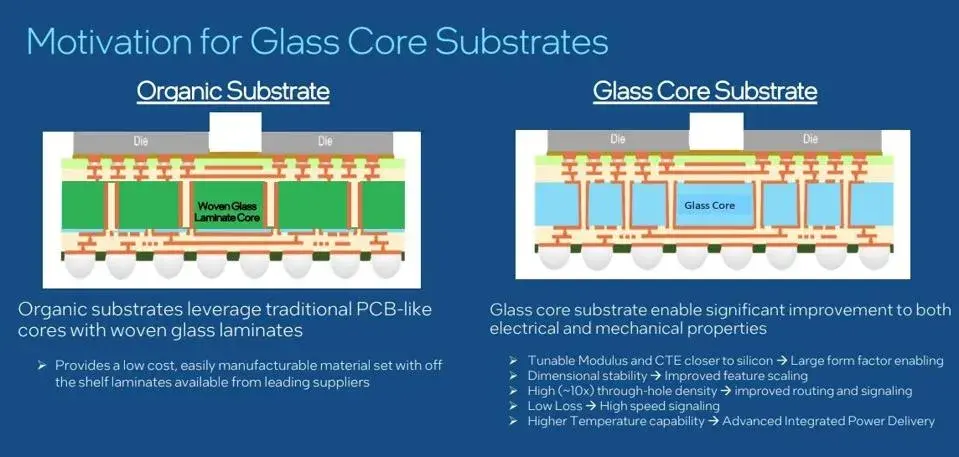
2023年9月,英特爾宣佈推出業界首批用於下一代先進封裝的玻璃基板之一,計劃在本十年後半期推出,也就是2026年至2030年推出。
英特爾高級副總裁兼裝配和測試開發總經理巴巴克·薩比 (Babak Sabi)表示:“經過十年的研究,英特爾已經實現了業界領先的先進封裝玻璃基板。我們期待推出這些尖端技術,讓我們的關鍵參與者和代工客户在未來幾十年受益。”
據瞭解,10年前,英特爾向美國亞利桑那州的工廠投資 10 億美元,建立了玻璃基板研發線和供應鏈,其在推動下一代封裝方面有着悠久的歷史,在 20 世紀 90 年代引領行業從陶瓷封裝向有機封裝的轉變,率先實現鹵素和無鉛封裝,併發明瞭先進的嵌入式芯片封裝技術。
而三星很快也跟隨着英特爾腳步,加入到了這場競賽當中。2024年1月的 CES 2024 上,三星電子提出將在今年建立玻璃基板試製品產線,目標是2025年產出試製品,2026年實現量產。
而在今年3月,三星電子已開始與三星電機和三星顯示等主要電子關聯公司聯合研發玻璃基板,預計三星電機將貢獻其在半導體與基板結合方面的專有技術,而三星顯示器則將貢獻玻璃工藝。據瞭解,這是三星電子首次與三星電機和三星顯示等電子元件公司共同開展玻璃基板研究。
當然,三星和英特爾並不是唯一致力於下一代基板技術的公司。日本製造商 Ibiden 也加入了基於玻璃的設計研發工作,SK集團旗下的SKC已成立子公司Absolux,以開發新的量產能力,其已經與 AMD 等公司建立了合作伙伴關係,而LG Innotek也表示,玻璃將是未來半導體封裝基板的主要材料,公司正考慮開發玻璃基板。
而在這些廠商之外,最值得關注的無疑是台積電。
儘管台積電此前並未提及關於玻璃基板這項技術,但考慮到這家公司在封裝領域的積累,其很可能早已有相關的技術儲備,據媒體報道,業界盛傳台積電已重啓玻璃基板的研發,以此來滿足未來英偉達想用FOPLP的需求。
此外,台灣半導體設備廠商也提前展開部署,與英特爾合作多年的鈦升發起,集結相關供應鏈成立了玻璃基板供應商E-core System大聯盟,意圖爭取英特爾和台積電的訂單。
對於封裝行業來説,FOPLP和玻璃基板就像一體兩面,想要大規模應用FOPLP,就需要更大的封裝基板,而更大的封裝基板,又繞不開玻璃基板,只要FOPLP的應用需求持續高漲,那麼玻璃基板的量產就會不斷加速。
從晶圓,到面板
事實上,FOPLP作為FOWLP的一項衍生出來的技術,在初期並未受到太多關注,一方面是應用產品有限,另一方面,這項技術考驗的不止是廠商的封裝能力,從工藝能力上看,FOPLP 可以看作是一種FOWLP和印刷電路板處理的技術,往往需要兩個不同行業的廠商通力合作,才能實現想要的效果。
這也是為什麼英特爾和三星在這一領域能夠進展最快的原因,前者身為多年的美國半導體行業龍頭,手握大半個美國半導體供應鏈,而後者本身就是一個龐大的集團,涉及到了半導體生產製造的方方面面,能夠更加迅速地解決問題。
而它們無疑也給台積電的封裝業務帶來了更多的壓力,伴隨FOPLP和玻璃基板逐步成熟,難保像英偉達和AMD這樣的廠商會因為技術原因而轉投其他封裝廠商。
此外,FOPLP和玻璃基板的崛起,也讓我們看到了更多面板級封裝的機會,由於兩種技術都採用類似的面板尺寸,在提高芯片密度、降低成本和提高製造效率等方面實現了互補,未來的封裝行業極有可能往這一維度發展。
在它們重新定義先進封裝的格局後,誰又能吃到最多的紅利呢?