博通發佈業界首創3.5D XDSiP平台,引領AI計算革新_風聞
科闻社-科闻社官方账号-天助自助者48分钟前

在人工智能(AI)與高性能計算(HPC)領域的需求不斷增長之際,博通(Broadcom)近日發佈了一項革命性創新——3.5D eXtreme Dimension System in Package(XDSiP)封裝平台。這是業界首次實現的3.5D Face-to-Face(F2F)封裝技術,為芯片設計與系統封裝樹立了新標杆。該技術結合了先進的台積電製程,整合了超過6,000 平方毫米的3D堆疊硅芯片和多達12個高帶寬內存(HBM)模組,全面提升了芯片的性能、能效和集成密度。
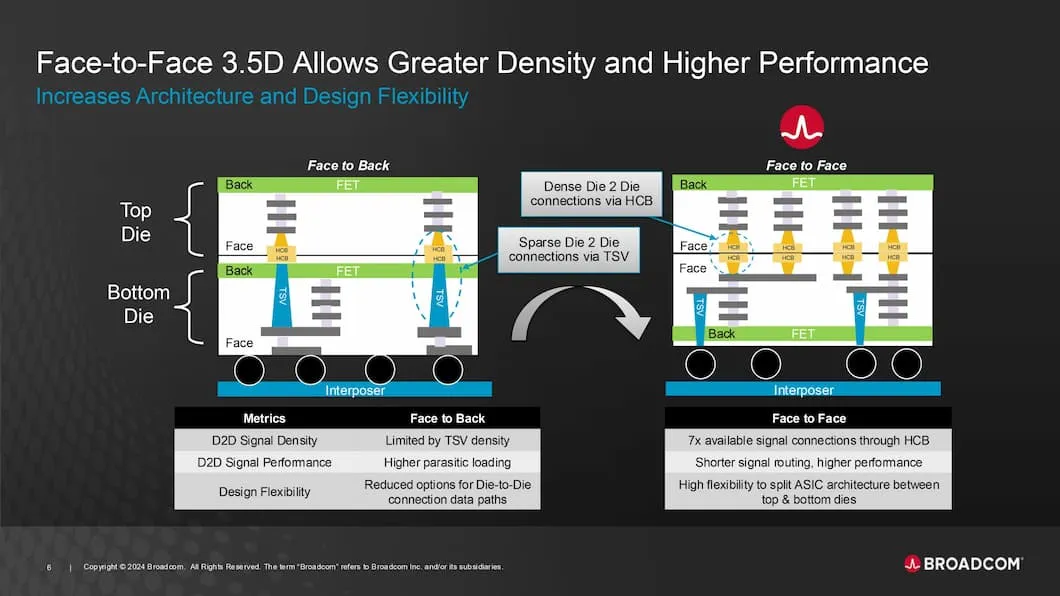
3.5D XDSiP平台通過將2.5D技術與3D堆疊技術結合,創造出真正意義上的“3.5D”封裝模式。該平台採用台積電的CoWoS-L技術,使總封裝面積達到4,719 平方毫米,可以容納邏輯IC、HBM模組以及多種I/O芯片。其核心創新是採用F2F(面對面)堆疊技術,通過銅混合鍵合(Hybrid Copper Bonding, HCB),直接連接上下硅片的金屬層,從根本上取代傳統的硅穿孔(TSV)方案。
這一F2F堆疊技術在以下幾方面展現出顯著優勢:
提升信號密度:與傳統F2B(face-to-back)技術相比,F2F技術讓堆疊晶粒之間的信號連接數量增加7倍,大幅提高數據傳輸效率。
降低功耗:Die-to-Die接口的功耗降低至原來的10%,顯著改善了能效比,為數據中心和其他高性能計算設備提供了更具可持續性的解決方案。
縮短延遲時間:通過減少堆疊內計算單元、內存和I/O組件之間的延遲,進一步優化了整體性能。
緊湊設計:更小的中介層和封裝尺寸,降低了材料和製造成本,同時解決了封裝翹曲問題,為高性能芯片的設計提供更多靈活性。
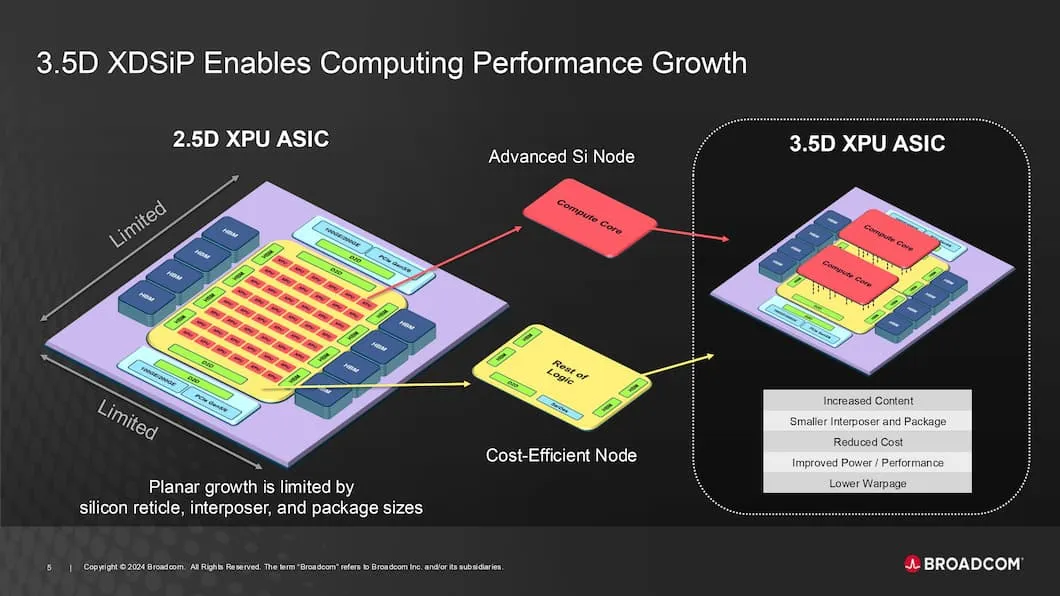
博通與台積電在3.5D技術研發上密切合作,將台積電的N2工藝與先進的封裝技術相結合,實現了多維芯片堆疊的創新突破。3.5D XDSiP平台不僅支持採用台積電N2製程的邏輯芯片與HBM模組的整合,還為未來的客户定製解決方案提供了廣泛支持,包括HBM PHY、PCIe和GbE等IP模塊,甚至涵蓋矽光子技術。
目標客户包括Google、Meta和OpenAI等科技巨頭,這些公司對AI與HPC應用有着極高的性能需求。博通表示,其平台為客户設計下一代加速器(XPU)和計算ASIC提供了獨特的解決方案,使得不同功能的芯片可以根據性能和成本需求分配到最佳製程中。
此外,博通目前正與富士通合作開發基於Arm架構的2納米處理器“FUJITSU-MONAKA”。這一芯片將充分利用3.5D XDSiP平台的F2F堆疊技術,實現低功耗、高性能的全新突破。
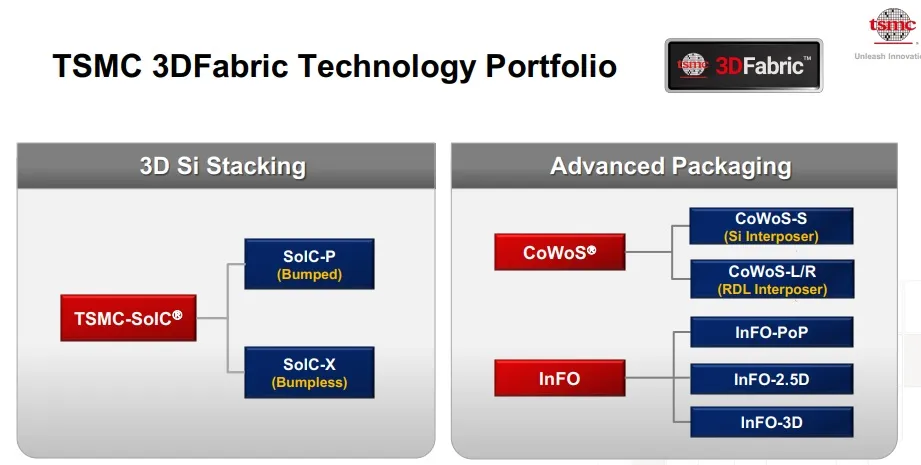
博通的3.5D XDSiP平台被認為是AI計算和HPC技術發展中的重要里程碑。從市場競爭角度來看,其超高信號密度、顯著能效提升和緊湊的封裝設計使之具備明顯優勢。儘管其他半導體公司也在快速迭代相似技術,但博通的F2F封裝創新,無疑為其在競爭激烈的AI市場贏得了一席之地。
行業分析人士指出,這一技術的推出不僅將推動更多廠商加速研發步伐,也將促使終端消費者對計算性能和能效提出更高期待。與此同時,市場對於低功耗、緊湊型芯片解決方案的需求正在快速增長,博通此舉很可能引發一場技術競賽,為整個行業注入新的活力。
*免責聲明:以上內容整理自網絡,僅供交流學習之用。如有內容、版權問題,請留言與我們聯繫進行刪除。