智能診斷+AI 雙核賦能 廣立微YAD貫穿全鏈路良率診斷分析_風聞
半导体行业观察-半导体行业观察官方账号-专注观察全球半导体最新资讯、技术前沿、发展趋势。27分钟前
長期以來,良率一直被視為芯片廠商和晶圓代工廠的生命線,其不僅是成本控制的關鍵因素,更是提升生產效率、增加產能以及增強市場競爭力的核心驅動力。
隨着設計與工藝複雜度的提升,先進製程下的芯片良率問題已不再侷限於單點缺陷,而是呈現出更多系統性、多源頭、跨層級的複合特徵。DFT 作為結構性測試的關鍵入口,在發現特定故障類型方面仍發揮着基礎作用。然而,依靠 DFT 工具本身的局部診斷,往往難以有效識別出由製造偏差、版圖熱點、測試邊界效應等引發的複雜失效模式。
為實現更高效的良率提升,業界越來越多地轉向跨領域數據分析,即將 DFT 測試數據與芯片製造過程數據(如版圖、製程監控、封測結果)進行關聯分析。但傳統的分析流程中,設計與製造數據分散、系統不互通,導致工程師在根因追溯、結果驗證等環節效率低下、週期拉長。
 編輯廣立微YAD良率感知大數據診斷分析平台,為破解這一痛點而生。廣立微YAD不僅支持主流DFT工具診斷報告的智能解析,更可與廣立微DATAEXP大數據分析平台深度集成,聯動DATAEXP-YMS(良率管理系統),將芯片設計規則、製造過程參數、在線測試(WAT/CP)數據、失效物理分析(PFA)結果等跨域數據流即時關聯,構建起覆蓋“設計-製造-測試-分析”全鏈路數據的診斷圖譜,讓工程師從繁瑣的數據比對中解放出來,聚焦於高價值的良率優化決策。
編輯廣立微YAD良率感知大數據診斷分析平台,為破解這一痛點而生。廣立微YAD不僅支持主流DFT工具診斷報告的智能解析,更可與廣立微DATAEXP大數據分析平台深度集成,聯動DATAEXP-YMS(良率管理系統),將芯片設計規則、製造過程參數、在線測試(WAT/CP)數據、失效物理分析(PFA)結果等跨域數據流即時關聯,構建起覆蓋“設計-製造-測試-分析”全鏈路數據的診斷圖譜,讓工程師從繁瑣的數據比對中解放出來,聚焦於高價值的良率優化決策。
“DFT高效診斷+YAD智能分析”協同
廣立微 YAD 作為一款專業良率分析與提升工具,深耕於 DFT(可測性設計)與良率分析領域,賦能半導體設計與製造企業高效完成良率分析及根因定位,構建從芯片設計診斷到量產良率提升的全流程分析閉環,進而縮短良率優化週期、降低生產成本,並顯著提升產品市場競爭力。
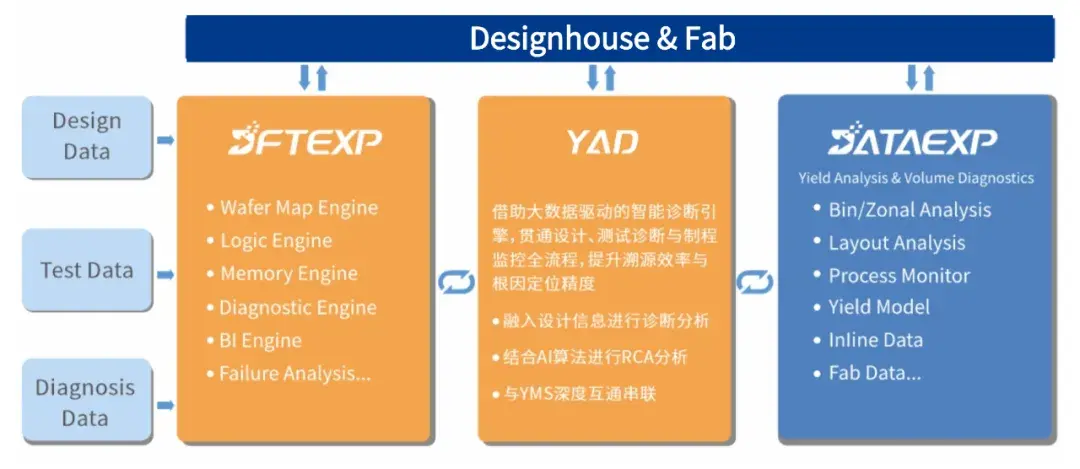 編輯YAD支持解析各類主流DFT診斷報告,集成YMS分析系統,全方位地結合電路設計數據、DFT診斷數據、芯片測試數據及芯片製造數據,協同優化設計與製造,深入挖掘良率失效根因。
編輯YAD支持解析各類主流DFT診斷報告,集成YMS分析系統,全方位地結合電路設計數據、DFT診斷數據、芯片測試數據及芯片製造數據,協同優化設計與製造,深入挖掘良率失效根因。
客户價值
YAD全面滿足產品和測試工程團隊的需求,藉助大數據驅動的智能診斷引擎,貫通設計、測試診斷與製程監控全流程,提升溯源效率與根因定位精度。YAD已在多個客户的實際案例中得到驗證,並獲得了高度認可,為半導體設計與製造企業帶來了顯著的價值:
1. 提升分析效率
強大的圖形化界面和報告功能,結合圖形化操作和全流程分析方案,快速提升良率分析效率,從數週縮短至數小時。
2. 提高根因分析準確率
通過AI算法結合全流程數據進行RCA分析,高精度多維度識別失效根因,自動推薦PFA候選者,提高根因分析準確率。
3. 識別隱藏系統性設計問題
融入設計信息進行診斷良率分析,通過數據挖掘提前識別潛在的系統性設計問題。
4. 多維度數據分析與驗證
與YMS深度互通串聯,通過多維度動態調整分析數據篩分診斷分析範圍,通過多維度數據相互驗證良率失效根因。
5. 高度智能自動化
通過構建全自動化的分析流程體系,最大程度降低人工介入,進行系統化數據管理。
核心功能
01.全流程數據貫通
藉助標準化數據技術,YAD支持適配主流DFT診斷報告進行良率診斷分析。通過有效結合電路物理設計籤核(sign-off)數據,可幫助客户解決識別系統性時序及功耗失效根因問題。
 編輯此外,結合廣立微DataEXP大數據平台,YAD可與YMS深度集成,串聯芯片CP數據、Inline Metrology、WAT、Defect數據,補齊芯片設計診斷到量產良率提升的閉環,實現多維度數據下鑽分析。
編輯此外,結合廣立微DataEXP大數據平台,YAD可與YMS深度集成,串聯芯片CP數據、Inline Metrology、WAT、Defect數據,補齊芯片設計診斷到量產良率提升的閉環,實現多維度數據下鑽分析。
02.智能化診斷分析
YAD通過數據挖掘和良率相關分析,融合先進AI算法模型,提供多種算法實現更準確的根因診斷分析(RCA, Root Cause Analysis)。
結合缺陷的版圖圖形模式分析(LPA, Layout Pattern Analysis),支持識別出某些特定的版圖圖形,通過版圖圖形聚類功能及高度優化的自動化算法分析由版圖圖形模式造成的系統性失效根因,支持用户基於DFM hotspot庫進行DFM-HIT分析。
YAD通過智能化診斷分析可精準定位在設計和製造端導致良率損失的系統性根因,並生成缺陷根因概率圖,可智能推薦PFA候選項,方便用户快速定位問題。針對Memory診斷分析,YAD支持通過Bitmap分析尋找匹配的缺陷模式。
 編輯▲Wafer Pattern →RCA
編輯▲Wafer Pattern →RCA
廣立微INF-AI大模型平台包含WPA、ADC、VM等智能化分析模塊,YAD可以結合WPA進行晶圓空間模式分析,對Wafer進行Pattern聚類、分類、匹配分析,快速篩選特徵Pattern數據進行根因診斷分析。
03.可視化交互與展示
YAD支持診斷報告可視化分析,提供與缺陷相關的電路圖和佈局信息,顯著節省時間。通過直觀的Wafer Map視圖,靈活支持數據關聯分析,幫助用户快速高效進行診斷分析。
04.便捷PFA選取
YAD支持通過常規RCA分析、AI-RCA分析快速定位可能的失效根因,系統支持顯示PFA路徑,自動推薦最佳物理失效分析(PFA)候選者,顯著提高PFA命中率,減少人工挑選的時間和成本。藉助內置的廣立微LayoutVision版圖可視化工具,可全局顯示缺陷的佈局信息,並通過直觀的圖形化界面進一步追蹤失效路徑及分析其影響。
廣立微YAD將分散的設計、工藝、測試數據轉化為良率提升的核心動能,其構建的智能診斷平台,不僅打破數據孤島,更通過 AI 算法從海量參數中鎖定關鍵失效模式,快速完成根因定位。未來,YAD 將持續推動數據智能與製造場景的深度融合,成為連接芯片設計與智能診斷的核心樞紐。
歡迎聯繫諮詢,獲取更多信息
聯繫郵箱:[email protected]
關於廣立微
杭州廣立微電子股份有限公司(股票代碼:301095)是領先的集成電路EDA軟件與晶圓級電性測試設備供應商,公司專注於芯片成品率提升和電性測試快速監控技術,是國內外多家大型集成電路製造與設計企業的重要合作伙伴。公司提供EDA軟件、電路IP、WAT電性測試設備以及與芯片成品率提升技術相結合的整套解決方案,在集成電路設計到量產的整個產品週期內實現芯片性能、成品率、穩定性的提升,成功案例覆蓋多個集成電路工藝節點。