HBM4,恐漲價30%_風聞
半导体产业纵横-半导体产业纵横官方账号-赋能中国半导体产业,我们一直在路上。1小时前

本文由半導體產業縱橫(ID:ICVIEWS)綜合
新一代HBM產品,更貴了。
根據TrendForce集邦諮詢最新研究,HBM技術發展受AI Server需求帶動,三大原廠積極推進HBM4產品進度。由於HBM4的I/O(輸入/輸出接口)數增加,複雜的芯片設計使得晶圓面積增加,且部分供應商產品改採邏輯芯片架構以提高性能,皆推升了成本。鑑於HBM3e剛推出時的溢價比例約為20%,預計製造難度更高的HBM4溢價幅度將突破30%。
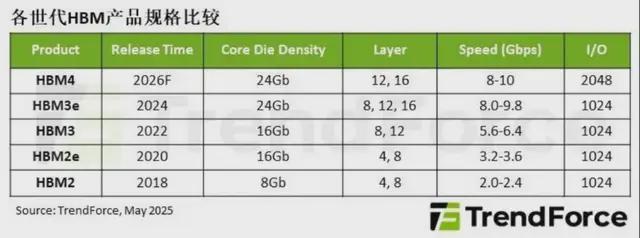
AI芯片領先廠商英偉達於今年GTC大會亮相最新Rubin GPU,AMD則有MI400與之抗衡,上述產品都將搭載HBM4。
由於需求強勁,TrendForce集邦諮詢預估2026年HBM市場總出貨量預計將突破30Billion Gb,HBM4的市佔率則隨着供應商持續放量而逐季提高,預計於2026年下半正式超越HBM3e系列產品,成為市場主流。至於供應商表現,預期SK hynix將以過半的市佔率穩居領導地位,Samsung與Micron(美光科技)仍待產品良率與產能表現進一步提升,才有機會在HBM4市場迎頭趕上。
3月19日,韓國半導體供應商SK海力士宣佈推出面向AI的超高性能DRAM新產品12層HBM4,並在全球首次向主要客户提供其樣品。SK海力士表示,公司將在下半年完成量產準備。
HBM4屬於第六代HBM產品,英偉達將是SK海力士的首個客户,用於明年的Rubin架構數據中心GPU上。SK海力士引入了在HBM3E獲得認可的Advanced MR-MUF工藝,從而在現有12層堆疊上達到了最大36GB容量,I/O接口速度達8Gbps,帶寬可提高至2TB/s。新工藝不但能控制芯片的翹曲現象,還有效提升了散熱性能,由此最大程度地提高了產品的穩定性。
據SK海力士介紹,4月在台積電北美技術論壇上展示的16層堆疊HBM4具有高達 48 GB 的容量、2.0 TB/s 帶寬和額定 8.0 Gbps 的 I/O 速度,其Logic Die則是由台積電代工。SK 海力士表示,他們正在尋求在 2025 年下半年之前進行大規模生產,這意味着該工藝最早可能在今年年底集成到產品中。
SK海力士已經穩固了Nvidia AI半導體“Blackwell”系列HBM3E的主要供應商地位,並且有望在全球率先供應預定於今年年底量產的下一代HBM4樣品,從而繼續保持領先地位。截至去年第四季度,HBM佔 SK 海力士 DRAM 總銷售額的 40% 以上。
三星的HBM4開發工作正在按計劃進行,且於2025年下半年實現HBM4的量產,並預計2026年開始商業供應。
據EBN報道,三星已經將混合鍵合技術引入到第六代HBM產品,也就是HBM4,早於競爭對手SK海力士。這不僅顯著改善了發熱問題,而且還明顯提升了I/O數量。隨着堆疊層數的增加,需要縮小芯片之間的間隙,引入混合鍵合技術可以縮小間隙,滿足需要更多垂直堆疊層數的HBM產品的生產。
目前SK海力士採用的是MR-RUF技術,將半導體芯片附着在電路上,使用EMC(液態環氧樹脂模塑料)填充芯片之間或芯片與凸塊之間的間隙。相比之下,三星和美光使用的是TC NCF技術,需要高温高壓將材料固化再熔化,然後進行清洗。這個過程涉及2-3個步驟,而MR-RUF技術可以在不需要清洗的情況下一步完成整個過程。
混合鍵合是一種3D集成技術,使用特殊材料填充和連接芯片,不需要凸塊。這種材料類似於液體或膠水,將提供散熱和芯片保護,從而實現更薄的整體芯片堆棧。與傳統的基於凸塊的堆疊相比,具有更低的電阻和電容、更高的密度、更好的熱性能、以及更薄的3D堆棧。
不過混合鍵合技術現階段也存在一些問題,比如成本較高,所需的專用設備比傳統封裝工具貴得多,並且需要更多的晶圓廠物理空間。這樣會影響資本效率,尤其是在晶圓廠佔地面積有限的情況下,這也是存儲器供應商謹慎行事的主要原因之一,因此SK海力士暫時也只是將混合鍵合作為備用工藝。
當前,HBM4的市場需求強勁,被廣泛應用於AI、深度學習和高性能計算等領域。此前,英偉達CEO黃仁勳曾要求SK海力士提前六個月供應HBM4芯片。此外,特斯拉最近也向SK海力士和三星電子錶達採購HBM4的意向,用於正在開發的AI數據中心及其自動駕駛汽車。而微軟、Meta向三星電子採購定製HBM4芯片。
*聲明:本文系原作者創作。文章內容系其個人觀點,我方轉載僅為分享與討論,不代表我方贊成或認同,如有異議,請聯繫後台。